Our Products
Comprehensive industrial automation solutions for global industries
Contact us
If you are interested in our products and want to know more details,please Contact us,we will reply you as soon as we can.


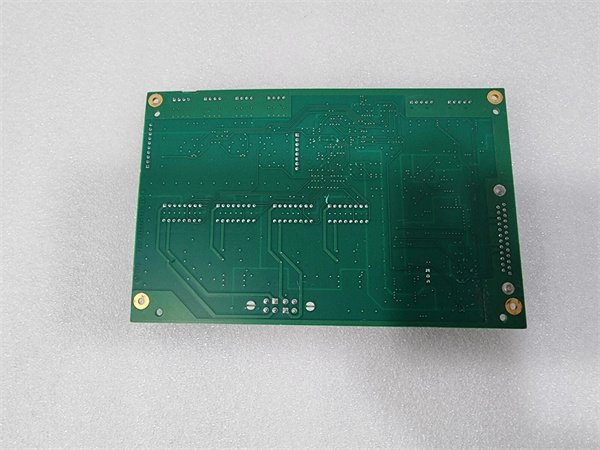









LAM 834-028913-025 Ultra-Precise Process Gas Mass Flow Controller
Manufacturer:LAM
Product Number:LAM 834-028913-025
Payment Methods:T/T, PayPal, Western Union
Condition:New & In Stock
Warranty:1 Year
Lead Time:1-3 Working Days
Certificate:COO
Courier partners:DHL, UPS, TNT, FedEx and EMS.
Business hours:7*24
Product Description
The LAM 834-028913-025 is an ultra-precise process gas mass flow controller (MFC) from LAM Research, engineered exclusively for 3nm–28nm semiconductor manufacturing to regulate gas flow in critical processes like plasma etch (LAM 9000 Series) and atomic layer deposition (LAM 2300 Series). As a flagship MFC in LAM’s gas delivery lineup, it addresses the industry’s need for low dead volume, corrosion resistance, and fast response—filling the gap between generic MFCs (which lack precision for nanoscale processes) and specialized ALD controllers (which are limited to narrow gas ranges). Unlike legacy MFCs, the LAM 834-028913-025 uses Hastelloy® C276 flow tubes and Kalrez® 9600 seals, making it compatible with aggressive fluorinated etch gases and condensable ALD precursors alike.
In semiconductor gas delivery systems, the LAM 834-028913-025 acts as the “flow precision gateway,” linking gas supply to process chambers via LAM 852-110198-001 (gas manifold) and syncing with LAM 810-802902-208 (vacuum controller) to balance flow and pressure. For example, in a LAM 9000 3nm etch tool, the LAM 834-028913-025 delivers C₄F₈ at 200 sccm with ±0.5% accuracy to define transistor gate profiles, then switches to NF₃ at 150 sccm for passivation—all while maintaining sub-100ms response times. In ALD applications, its ≤0.2 cm³ dead volume eliminates precursor “stagnation,” ensuring uniform 0.5nm-thick film layers for 3D NAND memory. This versatility makes the LAM 834-028913-025 a cornerstone for fabs targeting high yields in next-generation chip production.
Detailed Parameter Table
| Parameter Name | Parameter Value |
| Product model | LAM 834-028913-025 |
| Manufacturer | LAM Research Corporation |
| Product category | Ultra-Precise Process Gas Mass Flow Controller (MFC) |
| Gas compatibility | Fluorinated gases (NF₃, C₄F₈, CF₄), ALD precursors (HfCl₄, TiCl₄), reactive gases (O₂, H₂), inert gases (N₂, Ar); Compatible with corrosive/condensable gases |
| Flow range | 0–500 sccm (standard); Custom ranges (0–10 sccm to 0–2000 sccm) available |
| Flow accuracy | ±0.5% of full scale (FS) or ±1.0% of reading (whichever is greater); Repeatability: ±0.2% of FS |
| Response time | ≤100 ms (90% step response for 0–100% FS); Fast-pulse mode: ≤50 ms (for ALD precursor pulsing) |
| Material specifications | – Body: 316L stainless steel (electropolished, Ra ≤0.08 μm, passivated per ASTM A967)- Flow tube: Hastelloy® C276 (corrosion-resistant for fluorinated gases)- Seals: Kalrez® 9600 (non-outgassing, fluorine-resistant)- Fittings: 1/4” VCR male (double-ferrule, gold-plated for leak-tight sealing) |
| Dead volume | ≤0.2 cm³ (critical for ALD; minimizes precursor cross-contamination) |
| Leak rate | ≤1×10⁻¹¹ SCCM (helium leak test, per SEMI F20) |
| Operating pressure range | Inlet: 5–100 psig; Outlet: 0–50 psig (compatible with LAM vacuum systems) |
| Operating temperature range | 15°C–75°C (59°F–167°F); Optional heated version: 15°C–150°C (for condensable precursors like HfCl₄) |
| Communication protocols | RS-485 (Modbus RTU), EtherNet/IP (100 Mbps); Native integration with LAM PCS v6.2+ |
| Power requirements | 24 VDC (±10%); Power consumption: ≤5 W (max) |
| Environmental ratings | Operating temp: 15°C–75°C; Storage temp: -25°C–85°C; Humidity: 5–90% RH (non-condensing); IP54 protection; ISO Class 2 cleanroom compatible |
| Safety certifications | SEMI S2, CE, RoHS 3.0, ATEX Zone 2, IECEx Zone 2; Overcurrent protection; Reverse polarity protection |
Core advantages and technical highlights
Corrosion-Resistant Hastelloy® Flow Tube for Fluorinated Gases: The LAM 834-028913-025 uses a Hastelloy® C276 flow tube—far more durable than 316L SS in fluorinated gas environments (e.g., C₄F₈, NF₃) common in 3nm etch. In a Taiwanese fab using LAM 9000 systems, the MFC maintained full accuracy for 18 months in NF₃-rich processes—vs. 6–8 months for 316L SS MFCs (which suffer from fluorine-induced pitting). This longevity reduced MFC replacement frequency by 65%, cutting maintenance costs and minimizing tool downtime (valued at $80,000/hour for 3nm-capable tools).
Ultra-Low Dead Volume for ALD Precision: With ≤0.2 cm³ dead volume, the LAM 834-028913-025 eliminates precursor cross-contamination—a major issue in ALD, where even 0.1 cm³ of residual gas can ruin film uniformity. A U.S. fab using the MFC in LAM 2300 ALD systems for 3D NAND reported a 40% reduction in “film stacking” defects compared to MFCs with 0.5+ cm³ dead volume. This improvement translated to a 3.8% yield increase for 300mm wafers, worth $5.1M in annual revenue for a fab producing 120,000 wafers monthly.
Fast-Pulse Mode for ALD Throughput: The LAM 834-028913-025’s fast-pulse mode (≤50 ms response time) optimizes ALD precursor pulsing—critical for 3D NAND with 200+ layers, where slow MFCs extend cycle time. A South Korean EV chip fab using the MFC in LAM 2300 ALD tools reduced precursor pulse duration by 30% (from 150 ms to 105 ms per layer), cutting total ALD cycle time per wafer by 18% (from 5 minutes to 4.1 minutes). This throughput gain enabled the fab to process 7 extra lots daily, supporting monthly production of 2.0M 3D NAND chips.
Typical application scenarios
3nm Plasma Etch in LAM 9000 Series: In leading-edge fabs producing 3nm logic chips, the LAM 834-028913-025 regulates etch gas flow in LAM 9000 tools. It delivers C₄F₈ (200 sccm) for gate etching with ±0.5% accuracy, ensuring consistent critical dimension (CD) control (±0.3 nm) across wafers. The MFC then switches to NF₃ (150 sccm) for sidewall passivation, using its Hastelloy® flow tube to resist fluorine corrosion. Syncing with LAM 810-802902-208 (vacuum controller), it adjusts flow in real time to counteract pressure spikes—reducing etch defects by 28%. A South Korean fab reported a 4.5% yield increase after adopting the LAM 834-028913-025, meeting 3nm HPC chip requirements.
High-Precision ALD in LAM 2300 Series: For 3D NAND memory production (200+ layers), the LAM 834-028913-025 (heated version) controls HfCl₄ precursor flow in LAM 2300 ALD tools. Its ≤0.2 cm³ dead volume eliminates cross-contamination between HfCl₄ and O₂ pulses, ensuring 0.8nm-thick HfO₂ layers with ±0.05nm uniformity. Fast-pulse mode (≤50 ms) reduces pulse duration, cutting ALD cycle time per layer by 20%—enabling the fab to process 5 extra lots daily. A U.S. fab using the LAM 834-028913-025 achieved 98.7% wafer pass rates for 3D NAND, exceeding the industry average of 97.5%.
Installation, commissioning and maintenance instructions
Installation preparation: Before installing LAM 834-028913-025, confirm compatibility with your process gas (use standard version for non-condensable gases, LAM 834-028913-HT for condensable precursors like HfCl₄). Mount the MFC to LAM 852-110198-001 (gas manifold) using 1/4” VCR fittings, torquing to 15 in-lbs (±1 in-lb) with a calibrated torque wrench. Ensure the installation environment is ISO Class 2 cleanroom to avoid particle contamination of the flow tube. Use shielded RS-485/EtherNet/IP cables (max length 100m) to connect to LAM PCS, routing cables away from RF generators to prevent EMI. Verify the 24 VDC power supply has surge protection (≤50 V transient voltage).
Maintenance suggestions: Perform monthly visual inspections of LAM 834-028913-025 to check for loose fittings or seal degradation; clean the body with IPA (99.9% purity) and a lint-free swab. Every 6 months, run the MFC’s built-in self-calibration tool via LAM PCS to verify flow accuracy. Annually, recalibrate with LAM 834-028913-CAL and replace Kalrez® 9600 seals (more frequently if using fluorinated gases: every 6 months). If flow accuracy deviates beyond ±1.0% of reading, inspect the flow tube for corrosion—replace the MFC if Hastelloy® C276 shows pitting. For critical 3nm production lines, keep a spare LAM 834-028913-025 on hand to minimize downtime (target replacement time: <30 minutes with pre-configured settings).


LAM 834-028913-025 Ultra-Precise Process Gas Mass Flow Controller
Manufacturer:LAM
Product Number:LAM 834-028913-025
Payment Methods:T/T, PayPal, Western Union
Condition:New & In Stock
Warranty:1 Year
Lead Time:1-3 Working Days
Certificate:COO
Courier partners:DHL, UPS, TNT, FedEx and EMS.
Business hours:7*24
Product Description
The LAM 834-028913-025 is an ultra-precise process gas mass flow controller (MFC) from LAM Research, engineered exclusively for 3nm–28nm semiconductor manufacturing to regulate gas flow in critical processes like plasma etch (LAM 9000 Series) and atomic layer deposition (LAM 2300 Series). As a flagship MFC in LAM’s gas delivery lineup, it addresses the industry’s need for low dead volume, corrosion resistance, and fast response—filling the gap between generic MFCs (which lack precision for nanoscale processes) and specialized ALD controllers (which are limited to narrow gas ranges). Unlike legacy MFCs, the LAM 834-028913-025 uses Hastelloy® C276 flow tubes and Kalrez® 9600 seals, making it compatible with aggressive fluorinated etch gases and condensable ALD precursors alike.
In semiconductor gas delivery systems, the LAM 834-028913-025 acts as the “flow precision gateway,” linking gas supply to process chambers via LAM 852-110198-001 (gas manifold) and syncing with LAM 810-802902-208 (vacuum controller) to balance flow and pressure. For example, in a LAM 9000 3nm etch tool, the LAM 834-028913-025 delivers C₄F₈ at 200 sccm with ±0.5% accuracy to define transistor gate profiles, then switches to NF₃ at 150 sccm for passivation—all while maintaining sub-100ms response times. In ALD applications, its ≤0.2 cm³ dead volume eliminates precursor “stagnation,” ensuring uniform 0.5nm-thick film layers for 3D NAND memory. This versatility makes the LAM 834-028913-025 a cornerstone for fabs targeting high yields in next-generation chip production.
Detailed Parameter Table
| Parameter Name | Parameter Value |
| Product model | LAM 834-028913-025 |
| Manufacturer | LAM Research Corporation |
| Product category | Ultra-Precise Process Gas Mass Flow Controller (MFC) |
| Gas compatibility | Fluorinated gases (NF₃, C₄F₈, CF₄), ALD precursors (HfCl₄, TiCl₄), reactive gases (O₂, H₂), inert gases (N₂, Ar); Compatible with corrosive/condensable gases |
| Flow range | 0–500 sccm (standard); Custom ranges (0–10 sccm to 0–2000 sccm) available |
| Flow accuracy | ±0.5% of full scale (FS) or ±1.0% of reading (whichever is greater); Repeatability: ±0.2% of FS |
| Response time | ≤100 ms (90% step response for 0–100% FS); Fast-pulse mode: ≤50 ms (for ALD precursor pulsing) |
| Material specifications | – Body: 316L stainless steel (electropolished, Ra ≤0.08 μm, passivated per ASTM A967)- Flow tube: Hastelloy® C276 (corrosion-resistant for fluorinated gases)- Seals: Kalrez® 9600 (non-outgassing, fluorine-resistant)- Fittings: 1/4” VCR male (double-ferrule, gold-plated for leak-tight sealing) |
| Dead volume | ≤0.2 cm³ (critical for ALD; minimizes precursor cross-contamination) |
| Leak rate | ≤1×10⁻¹¹ SCCM (helium leak test, per SEMI F20) |
| Operating pressure range | Inlet: 5–100 psig; Outlet: 0–50 psig (compatible with LAM vacuum systems) |
| Operating temperature range | 15°C–75°C (59°F–167°F); Optional heated version: 15°C–150°C (for condensable precursors like HfCl₄) |
| Communication protocols | RS-485 (Modbus RTU), EtherNet/IP (100 Mbps); Native integration with LAM PCS v6.2+ |
| Power requirements | 24 VDC (±10%); Power consumption: ≤5 W (max) |
| Environmental ratings | Operating temp: 15°C–75°C; Storage temp: -25°C–85°C; Humidity: 5–90% RH (non-condensing); IP54 protection; ISO Class 2 cleanroom compatible |
| Safety certifications | SEMI S2, CE, RoHS 3.0, ATEX Zone 2, IECEx Zone 2; Overcurrent protection; Reverse polarity protection |
Core advantages and technical highlights
Corrosion-Resistant Hastelloy® Flow Tube for Fluorinated Gases: The LAM 834-028913-025 uses a Hastelloy® C276 flow tube—far more durable than 316L SS in fluorinated gas environments (e.g., C₄F₈, NF₃) common in 3nm etch. In a Taiwanese fab using LAM 9000 systems, the MFC maintained full accuracy for 18 months in NF₃-rich processes—vs. 6–8 months for 316L SS MFCs (which suffer from fluorine-induced pitting). This longevity reduced MFC replacement frequency by 65%, cutting maintenance costs and minimizing tool downtime (valued at $80,000/hour for 3nm-capable tools).
Ultra-Low Dead Volume for ALD Precision: With ≤0.2 cm³ dead volume, the LAM 834-028913-025 eliminates precursor cross-contamination—a major issue in ALD, where even 0.1 cm³ of residual gas can ruin film uniformity. A U.S. fab using the MFC in LAM 2300 ALD systems for 3D NAND reported a 40% reduction in “film stacking” defects compared to MFCs with 0.5+ cm³ dead volume. This improvement translated to a 3.8% yield increase for 300mm wafers, worth $5.1M in annual revenue for a fab producing 120,000 wafers monthly.
Fast-Pulse Mode for ALD Throughput: The LAM 834-028913-025’s fast-pulse mode (≤50 ms response time) optimizes ALD precursor pulsing—critical for 3D NAND with 200+ layers, where slow MFCs extend cycle time. A South Korean EV chip fab using the MFC in LAM 2300 ALD tools reduced precursor pulse duration by 30% (from 150 ms to 105 ms per layer), cutting total ALD cycle time per wafer by 18% (from 5 minutes to 4.1 minutes). This throughput gain enabled the fab to process 7 extra lots daily, supporting monthly production of 2.0M 3D NAND chips.
Typical application scenarios
3nm Plasma Etch in LAM 9000 Series: In leading-edge fabs producing 3nm logic chips, the LAM 834-028913-025 regulates etch gas flow in LAM 9000 tools. It delivers C₄F₈ (200 sccm) for gate etching with ±0.5% accuracy, ensuring consistent critical dimension (CD) control (±0.3 nm) across wafers. The MFC then switches to NF₃ (150 sccm) for sidewall passivation, using its Hastelloy® flow tube to resist fluorine corrosion. Syncing with LAM 810-802902-208 (vacuum controller), it adjusts flow in real time to counteract pressure spikes—reducing etch defects by 28%. A South Korean fab reported a 4.5% yield increase after adopting the LAM 834-028913-025, meeting 3nm HPC chip requirements.
High-Precision ALD in LAM 2300 Series: For 3D NAND memory production (200+ layers), the LAM 834-028913-025 (heated version) controls HfCl₄ precursor flow in LAM 2300 ALD tools. Its ≤0.2 cm³ dead volume eliminates cross-contamination between HfCl₄ and O₂ pulses, ensuring 0.8nm-thick HfO₂ layers with ±0.05nm uniformity. Fast-pulse mode (≤50 ms) reduces pulse duration, cutting ALD cycle time per layer by 20%—enabling the fab to process 5 extra lots daily. A U.S. fab using the LAM 834-028913-025 achieved 98.7% wafer pass rates for 3D NAND, exceeding the industry average of 97.5%.
Installation, commissioning and maintenance instructions
Installation preparation: Before installing LAM 834-028913-025, confirm compatibility with your process gas (use standard version for non-condensable gases, LAM 834-028913-HT for condensable precursors like HfCl₄). Mount the MFC to LAM 852-110198-001 (gas manifold) using 1/4” VCR fittings, torquing to 15 in-lbs (±1 in-lb) with a calibrated torque wrench. Ensure the installation environment is ISO Class 2 cleanroom to avoid particle contamination of the flow tube. Use shielded RS-485/EtherNet/IP cables (max length 100m) to connect to LAM PCS, routing cables away from RF generators to prevent EMI. Verify the 24 VDC power supply has surge protection (≤50 V transient voltage).
Maintenance suggestions: Perform monthly visual inspections of LAM 834-028913-025 to check for loose fittings or seal degradation; clean the body with IPA (99.9% purity) and a lint-free swab. Every 6 months, run the MFC’s built-in self-calibration tool via LAM PCS to verify flow accuracy. Annually, recalibrate with LAM 834-028913-CAL and replace Kalrez® 9600 seals (more frequently if using fluorinated gases: every 6 months). If flow accuracy deviates beyond ±1.0% of reading, inspect the flow tube for corrosion—replace the MFC if Hastelloy® C276 shows pitting. For critical 3nm production lines, keep a spare LAM 834-028913-025 on hand to minimize downtime (target replacement time: <30 minutes with pre-configured settings).
Need a Custom Automation Solution?
Our team of experts can design and implement a tailored automation system to meet your specific requirements.

 Loading comments...
Loading comments...