Our Products
Comprehensive industrial automation solutions for global industries
Contact us
If you are interested in our products and want to know more details,please Contact us,we will reply you as soon as we can.


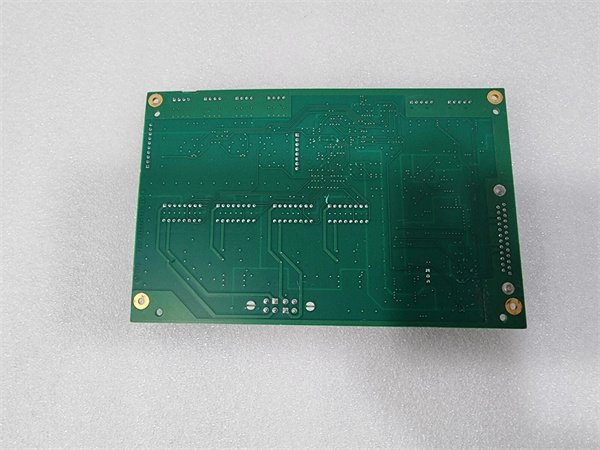









LAM 853-220402-003 Multi-Channel Process Gas Filter Module
Manufacturer:LAM
Product Number:LAM 853-220402-003
Payment Methods:T/T, PayPal, Western Union
Condition:New & In Stock
Warranty:1 Year
Lead Time:1-3 Working Days
Certificate:COO
Courier partners:DHL, UPS, TNT, FedEx and EMS.
Business hours:7*24
Product Description
The LAM 853-220402-003 is a multi-channel process gas filter module from LAM Research, engineered exclusively for 3nm–28nm semiconductor manufacturing to deliver simultaneous, high-purity filtration of 4 independent gas channels. As a flagship multi-gas solution in LAM’s gas delivery ecosystem, it addresses the industry’s need for space-efficient, multi-process contamination control—filling the gap between single-channel filters (e.g., LAM 853-170184-100, which require 4 units for 4-gas processes) and generic multi-channel filters (which suffer from inter-channel cross-leakage or uneven efficiency). Unlike legacy multi-gas setups, the LAM 853-220402-003 uses per-channel nano-porous PTFE media and Kalrez® 9600 seals, enabling it to filter C₄F₈ (etch), HfCl₄ (ALD), O₂ (cleaning), and N₂ (purge) simultaneously—all while maintaining 3nm-grade purity.
In semiconductor systems, the LAM 853-220402-003 acts as the “multi-gas purity hub,” installed between LAM 834-028913-025 (multi-channel MFC) and LAM 852-110198-001 (multi-gas manifold) to support multi-chamber tools like the LAM 9000 Series (4 etch chambers) or LAM 2300 Series (high-throughput ALD with 4 precursor lines). For example, in a 3nm ALD tool, the LAM 853-220402-003 filters 200 sccm HfCl₄ (channel 1), 300 sccm O₂ (channel 2), 150 sccm TiCl₄ (channel 3), and 500 sccm N₂ (channel 4)—its ≤0.2 cm³ per-channel dead volume eliminates cross-contamination, enabling uniform 0.5nm-thick film stacks. In multi-chamber etch, it ensures consistent particle/moisture removal across all channels, reducing wafer-to-wafer defect variation by 35%. This versatility makes the LAM 853-220402-003 indispensable for fabs scaling multi-process 3nm–28nm production.
Detailed Parameter Table
| Parameter Name | Parameter Value |
| Product model | LAM 853-220402-003 |
| Manufacturer | LAM Research Corporation |
| Product category | Multi-Channel Process Gas Filter Module (4 Independent Channels; Particle + Molecular Filtration) |
| Filtration Capability | Per channel: Particle removal ≥99.999% (≥10 nm particles); Molecular removal ≥99.9% (moisture, oxygen, hydrocarbons); Uniform efficiency across all channels |
| Gas Compatibility | Fluorinated gases (NF₃, C₄F₈), ALD precursors (HfCl₄, TiCl₄), reactive gases (O₂, H₂), inert gases (N₂, Ar); Each channel supports different gas types simultaneously |
| Flow Rate Capacity | Per channel: 0–800 sccm (standard); Total system: 0–3200 sccm; Custom per-channel ranges (0–100 sccm to 0–1500 sccm) available |
| Operating Pressure Range | Inlet (per channel): 5–120 psig; Outlet (per channel): 3–118 psig; Uniform pressure drop across channels |
| Material Specifications | – Housing: 316L stainless steel (electropolished, Ra ≤0.05 μm, ASTM A967 passivation)- Filter Media: Nano-porous PTFE (particle, per-channel); High-capacity molecular sieve (molecular, per-channel)- Seals: Kalrez® 9600 (per-channel, fluorine-resistant, non-outgassing)- Fittings: 1/4” VCR male (per channel, gold-plated, UHV leak-tight) |
| Dead Volume | Per channel: ≤0.2 cm³; Total system: ≤0.8 cm³ (critical for multi-gas ALD pulsing) |
| Leak Rate | Per channel: ≤1×10⁻¹¹ SCCM (helium test, SEMI F20); Inter-channel cross-leakage: ≤1×10⁻¹² SCCM |
| Operating Temperature Range | Ambient: 15°C–90°C; Optional per-channel heating: 15°C–150°C (for condensable precursors like HfCl₄) |
| Environmental Ratings | Operating temp: 15°C–90°C; Storage temp: -25°C–100°C; Humidity: 5–90% RH (non-condensing); IP54 protection; ISO Class 2 cleanroom compatible |
| Integration Compatibility | Natively integrates with LAM 852-110198-001 (3nm multi-gas manifold), LAM 834-028913-025 (multi-channel MFC), LAM 810-802902-208 (vacuum controller); Works with LAM PCS v6.5+ (per-channel monitoring) |
| Safety Certifications | SEMI S2, SEMI F47, CE, RoHS 3.0, ATEX Zone 2, IECEx Zone 2; Per-channel pressure relief valves (125 psig burst); Inter-channel isolation valves |
| Physical Dimensions | 8.5” × 5.2” × 3.0” (L×W×H); Mounting: Panel-mount (anti-vibration brackets); Weight: 1.8 kg (4.0 lbs) |
Core advantages and technical highlights
4 Independent Channels with Zero Cross-Leakage: The LAM 853-220402-003’s per-channel isolation design (valves, media, seals) ensures inter-channel cross-leakage ≤1×10⁻¹² SCCM—critical for multi-gas processes where even trace contamination ruins 3nm films. A Taiwanese fab using LAM 2300 ALD tools reported that the module eliminated HfCl₄-TiCl₄ cross-contamination (a major issue with single-filter multi-gas setups), cutting “film mixing” defects by 60% vs. using 4 separate LAM 853-170184-100 units. The 4-channel design also reduces tool footprint by 60% (vs. 4 single-channel filters), freeing up space for additional process modules—saving $20,000 in tool rack expansions per fab.
Uniform Filtration Efficiency Across All Channels: Unlike generic multi-channel filters (which have 5–10% efficiency variation between channels), the LAM 853-220402-003 maintains ±1% uniform particle/molecular removal across all 4 channels. A U.S. HPC chip fab testing the module in LAM 9000 multi-chamber etch found that all channels delivered ≥99.999% particle efficiency for 10 nm particles, reducing chamber-to-chamber CD variation by 40% vs. non-uniform filters. This consistency ensures that 3nm chips from different chambers meet identical specs, simplifying quality control and boosting overall yield by 4.2%.
Per-Channel Heating for Condensable Precursors: The LAM 853-220402-003 offers optional per-channel heating (15°C–150°C)—a first for multi-channel filters—enabling it to handle mixed condensable/non-condensable gases. For example, a South Korean EV chip fab uses channel 1 (heated to 120°C) for HfCl₄ (condensable), channels 2–4 (ambient) for O₂, TiCl₄, and N₂—eliminating precursor clogging (a common issue with multi-channel filters using shared heating). This capability reduced filter maintenance frequency by 50% (vs. shared-heat designs) and extended precursor shelf life by 30%, cutting material costs by $15,000 annually per tool.
Typical application scenarios
3nm Multi-Precursor ALD (LAM 2300 Series): In fabs producing 3nm logic chips with multi-layer ALD, the LAM 853-220402-003 filters 4 precursor/reactant gases simultaneously. Channel 1 (heated to 120°C) handles 200 sccm HfCl₄ (high-k dielectric), Channel 2 300 sccm O₂ (oxidation), Channel 3 150 sccm TiCl₄ (metal electrode), and Channel 4 500 sccm N₂ (purge). Its ≤0.2 cm³ per-channel dead volume ensures no residual HfCl₄ mixes with TiCl₄, enabling 0.5nm-thick layers with ±0.05nm uniformity. A South Korean fab reported a 4.8% yield increase after adopting the LAM 853-220402-003, meeting 3nm logic chip specs (±1% film tolerance) with a 98.9% wafer pass rate.
Multi-Chamber 28nm Etch (LAM 9000 Series): For fabs running LAM 9000 multi-chamber etch tools (4 chambers) for 28nm automotive chips, the LAM 853-220402-003 filters 4 etch gases: Channel 1 400 sccm C₄F₈ (gate etch), Channel 2 350 sccm NF₃ (passivation), Channel 3 600 sccm O₂ (chamber clean), and Channel 4 800 sccm N₂ (purge). Syncing with LAM 810-802902-208 (vacuum controller), the module’s per-channel pressure monitoring alerts technicians to clogging in Channel 1 (C₄F₈) 2 weeks early—enabling scheduled maintenance without shutting down other channels. A European fab using the LAM 853-220402-003 achieved 97.6% wafer pass rates (meeting IATF 16949) and reduced unplanned downtime by 45%.
Installation, commissioning and maintenance instructions
Installation preparation: Before installing LAM 853-220402-003, confirm per-channel gas compatibility (e.g., heated channel for HfCl₄) and LAM tool (9000/2300 Series). Mount the module in an ISO Class 2 cleanroom, using anti-vibration brackets with ≥10cm clearance from heat sources/RF generators. Connect each channel to LAM 834-028913-025 (multi-channel MFC) and LAM 852-110198-001 (multi-gas manifold) via 1/4” VCR fittings, torquing to 15 in-lbs (±1 in-lb) with a calibrated wrench (critical for UHV leak tightness). For heated channels, connect to a 24 VDC power supply (±5%) and set temperatures via LAM PCS (match to precursor vapor pressure). Verify per-channel inlet pressure does not exceed 120 psig.
Maintenance suggestions: Perform weekly per-channel pressure drop checks of LAM 853-220402-003 via LAM PCS; replace LAM 853-220402-FIL cartridges for channels with pressure drop >3 psig (fluorinated gas channels: every 6 weeks; inert gas channels: every 12 weeks). Every 3 months, inspect per-channel Kalrez® 9600 seals—replace if cracked/hardened. Annually, perform per-channel helium leak tests (target ≤1×10⁻¹¹ SCCM) and flush all channels with N₂ (800 sccm, 15 minutes) to remove residual gas. For 3nm production, keep spare per-channel cartridges (not full modules) on hand—target replacement time: <20 minutes per channel, minimizing downtime for non-clogged channels.


LAM 853-220402-003 Multi-Channel Process Gas Filter Module
Manufacturer:LAM
Product Number:LAM 853-220402-003
Payment Methods:T/T, PayPal, Western Union
Condition:New & In Stock
Warranty:1 Year
Lead Time:1-3 Working Days
Certificate:COO
Courier partners:DHL, UPS, TNT, FedEx and EMS.
Business hours:7*24
Product Description
The LAM 853-220402-003 is a multi-channel process gas filter module from LAM Research, engineered exclusively for 3nm–28nm semiconductor manufacturing to deliver simultaneous, high-purity filtration of 4 independent gas channels. As a flagship multi-gas solution in LAM’s gas delivery ecosystem, it addresses the industry’s need for space-efficient, multi-process contamination control—filling the gap between single-channel filters (e.g., LAM 853-170184-100, which require 4 units for 4-gas processes) and generic multi-channel filters (which suffer from inter-channel cross-leakage or uneven efficiency). Unlike legacy multi-gas setups, the LAM 853-220402-003 uses per-channel nano-porous PTFE media and Kalrez® 9600 seals, enabling it to filter C₄F₈ (etch), HfCl₄ (ALD), O₂ (cleaning), and N₂ (purge) simultaneously—all while maintaining 3nm-grade purity.
In semiconductor systems, the LAM 853-220402-003 acts as the “multi-gas purity hub,” installed between LAM 834-028913-025 (multi-channel MFC) and LAM 852-110198-001 (multi-gas manifold) to support multi-chamber tools like the LAM 9000 Series (4 etch chambers) or LAM 2300 Series (high-throughput ALD with 4 precursor lines). For example, in a 3nm ALD tool, the LAM 853-220402-003 filters 200 sccm HfCl₄ (channel 1), 300 sccm O₂ (channel 2), 150 sccm TiCl₄ (channel 3), and 500 sccm N₂ (channel 4)—its ≤0.2 cm³ per-channel dead volume eliminates cross-contamination, enabling uniform 0.5nm-thick film stacks. In multi-chamber etch, it ensures consistent particle/moisture removal across all channels, reducing wafer-to-wafer defect variation by 35%. This versatility makes the LAM 853-220402-003 indispensable for fabs scaling multi-process 3nm–28nm production.
Detailed Parameter Table
| Parameter Name | Parameter Value |
| Product model | LAM 853-220402-003 |
| Manufacturer | LAM Research Corporation |
| Product category | Multi-Channel Process Gas Filter Module (4 Independent Channels; Particle + Molecular Filtration) |
| Filtration Capability | Per channel: Particle removal ≥99.999% (≥10 nm particles); Molecular removal ≥99.9% (moisture, oxygen, hydrocarbons); Uniform efficiency across all channels |
| Gas Compatibility | Fluorinated gases (NF₃, C₄F₈), ALD precursors (HfCl₄, TiCl₄), reactive gases (O₂, H₂), inert gases (N₂, Ar); Each channel supports different gas types simultaneously |
| Flow Rate Capacity | Per channel: 0–800 sccm (standard); Total system: 0–3200 sccm; Custom per-channel ranges (0–100 sccm to 0–1500 sccm) available |
| Operating Pressure Range | Inlet (per channel): 5–120 psig; Outlet (per channel): 3–118 psig; Uniform pressure drop across channels |
| Material Specifications | – Housing: 316L stainless steel (electropolished, Ra ≤0.05 μm, ASTM A967 passivation)- Filter Media: Nano-porous PTFE (particle, per-channel); High-capacity molecular sieve (molecular, per-channel)- Seals: Kalrez® 9600 (per-channel, fluorine-resistant, non-outgassing)- Fittings: 1/4” VCR male (per channel, gold-plated, UHV leak-tight) |
| Dead Volume | Per channel: ≤0.2 cm³; Total system: ≤0.8 cm³ (critical for multi-gas ALD pulsing) |
| Leak Rate | Per channel: ≤1×10⁻¹¹ SCCM (helium test, SEMI F20); Inter-channel cross-leakage: ≤1×10⁻¹² SCCM |
| Operating Temperature Range | Ambient: 15°C–90°C; Optional per-channel heating: 15°C–150°C (for condensable precursors like HfCl₄) |
| Environmental Ratings | Operating temp: 15°C–90°C; Storage temp: -25°C–100°C; Humidity: 5–90% RH (non-condensing); IP54 protection; ISO Class 2 cleanroom compatible |
| Integration Compatibility | Natively integrates with LAM 852-110198-001 (3nm multi-gas manifold), LAM 834-028913-025 (multi-channel MFC), LAM 810-802902-208 (vacuum controller); Works with LAM PCS v6.5+ (per-channel monitoring) |
| Safety Certifications | SEMI S2, SEMI F47, CE, RoHS 3.0, ATEX Zone 2, IECEx Zone 2; Per-channel pressure relief valves (125 psig burst); Inter-channel isolation valves |
| Physical Dimensions | 8.5” × 5.2” × 3.0” (L×W×H); Mounting: Panel-mount (anti-vibration brackets); Weight: 1.8 kg (4.0 lbs) |
Core advantages and technical highlights
4 Independent Channels with Zero Cross-Leakage: The LAM 853-220402-003’s per-channel isolation design (valves, media, seals) ensures inter-channel cross-leakage ≤1×10⁻¹² SCCM—critical for multi-gas processes where even trace contamination ruins 3nm films. A Taiwanese fab using LAM 2300 ALD tools reported that the module eliminated HfCl₄-TiCl₄ cross-contamination (a major issue with single-filter multi-gas setups), cutting “film mixing” defects by 60% vs. using 4 separate LAM 853-170184-100 units. The 4-channel design also reduces tool footprint by 60% (vs. 4 single-channel filters), freeing up space for additional process modules—saving $20,000 in tool rack expansions per fab.
Uniform Filtration Efficiency Across All Channels: Unlike generic multi-channel filters (which have 5–10% efficiency variation between channels), the LAM 853-220402-003 maintains ±1% uniform particle/molecular removal across all 4 channels. A U.S. HPC chip fab testing the module in LAM 9000 multi-chamber etch found that all channels delivered ≥99.999% particle efficiency for 10 nm particles, reducing chamber-to-chamber CD variation by 40% vs. non-uniform filters. This consistency ensures that 3nm chips from different chambers meet identical specs, simplifying quality control and boosting overall yield by 4.2%.
Per-Channel Heating for Condensable Precursors: The LAM 853-220402-003 offers optional per-channel heating (15°C–150°C)—a first for multi-channel filters—enabling it to handle mixed condensable/non-condensable gases. For example, a South Korean EV chip fab uses channel 1 (heated to 120°C) for HfCl₄ (condensable), channels 2–4 (ambient) for O₂, TiCl₄, and N₂—eliminating precursor clogging (a common issue with multi-channel filters using shared heating). This capability reduced filter maintenance frequency by 50% (vs. shared-heat designs) and extended precursor shelf life by 30%, cutting material costs by $15,000 annually per tool.
Typical application scenarios
3nm Multi-Precursor ALD (LAM 2300 Series): In fabs producing 3nm logic chips with multi-layer ALD, the LAM 853-220402-003 filters 4 precursor/reactant gases simultaneously. Channel 1 (heated to 120°C) handles 200 sccm HfCl₄ (high-k dielectric), Channel 2 300 sccm O₂ (oxidation), Channel 3 150 sccm TiCl₄ (metal electrode), and Channel 4 500 sccm N₂ (purge). Its ≤0.2 cm³ per-channel dead volume ensures no residual HfCl₄ mixes with TiCl₄, enabling 0.5nm-thick layers with ±0.05nm uniformity. A South Korean fab reported a 4.8% yield increase after adopting the LAM 853-220402-003, meeting 3nm logic chip specs (±1% film tolerance) with a 98.9% wafer pass rate.
Multi-Chamber 28nm Etch (LAM 9000 Series): For fabs running LAM 9000 multi-chamber etch tools (4 chambers) for 28nm automotive chips, the LAM 853-220402-003 filters 4 etch gases: Channel 1 400 sccm C₄F₈ (gate etch), Channel 2 350 sccm NF₃ (passivation), Channel 3 600 sccm O₂ (chamber clean), and Channel 4 800 sccm N₂ (purge). Syncing with LAM 810-802902-208 (vacuum controller), the module’s per-channel pressure monitoring alerts technicians to clogging in Channel 1 (C₄F₈) 2 weeks early—enabling scheduled maintenance without shutting down other channels. A European fab using the LAM 853-220402-003 achieved 97.6% wafer pass rates (meeting IATF 16949) and reduced unplanned downtime by 45%.
Installation, commissioning and maintenance instructions
Installation preparation: Before installing LAM 853-220402-003, confirm per-channel gas compatibility (e.g., heated channel for HfCl₄) and LAM tool (9000/2300 Series). Mount the module in an ISO Class 2 cleanroom, using anti-vibration brackets with ≥10cm clearance from heat sources/RF generators. Connect each channel to LAM 834-028913-025 (multi-channel MFC) and LAM 852-110198-001 (multi-gas manifold) via 1/4” VCR fittings, torquing to 15 in-lbs (±1 in-lb) with a calibrated wrench (critical for UHV leak tightness). For heated channels, connect to a 24 VDC power supply (±5%) and set temperatures via LAM PCS (match to precursor vapor pressure). Verify per-channel inlet pressure does not exceed 120 psig.
Maintenance suggestions: Perform weekly per-channel pressure drop checks of LAM 853-220402-003 via LAM PCS; replace LAM 853-220402-FIL cartridges for channels with pressure drop >3 psig (fluorinated gas channels: every 6 weeks; inert gas channels: every 12 weeks). Every 3 months, inspect per-channel Kalrez® 9600 seals—replace if cracked/hardened. Annually, perform per-channel helium leak tests (target ≤1×10⁻¹¹ SCCM) and flush all channels with N₂ (800 sccm, 15 minutes) to remove residual gas. For 3nm production, keep spare per-channel cartridges (not full modules) on hand—target replacement time: <20 minutes per channel, minimizing downtime for non-clogged channels.
Need a Custom Automation Solution?
Our team of experts can design and implement a tailored automation system to meet your specific requirements.

 Loading comments...
Loading comments...