Our Products
Comprehensive industrial automation solutions for global industries
Contact us
If you are interested in our products and want to know more details,please Contact us,we will reply you as soon as we can.


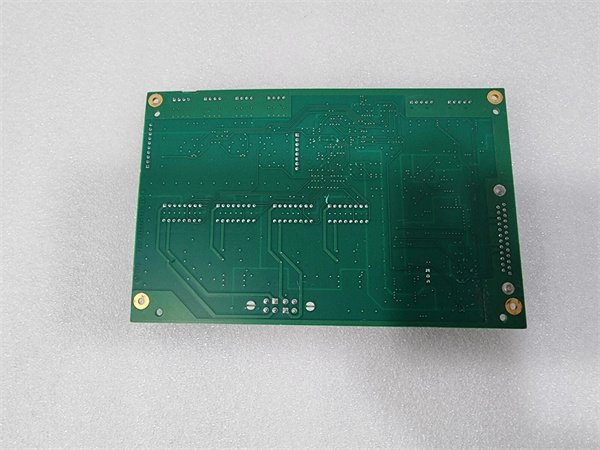











LAM 716-028721-268 Ultra-High Vacuum (UHV) Pressure Sensor
Manufacturer: LAM Research Corporation
Product Number: 716-028721-268
Category: Ultra-High Vacuum (UHV) Pressure Sensor (Capacitance Diaphragm Gauge)
Measurement Range: 1×10⁻⁶ Torr to 1 Torr
Accuracy: ±0.5% of reading (1×10⁻⁵ Torr to 1 Torr); ±1.5% of reading (below 1×10⁻⁵ Torr)
Response Time: ≤20 ms
Diaphragm Material: Inconel® with ceramic coating
Output Signal: 0-10 VDC analog, RS-485 digital
Process Port: 1/2" VCR male, 316L SS
Operating Temperature (Sensor Head): 20°C to 40°C (controlled); bakeable to 150°C
Power Supply: 24 VDC ±10%, 5 W max
Product Description
The LAM 716-028721-268 is a cutting-edge UHV pressure sensor engineered by LAM Research to address the most demanding vacuum monitoring needs of 3nm–5nm semiconductor manufacturing. Unlike broader-range sensors (e.g., LAM 716-011536-001) that balance UHV and low-vacuum performance, it is purpose-built for the ultra-precise UHV “sweet spot” (1×10⁻¹²–1×10⁻³ Torr)—where even a 0.01×10⁻¹² Torr pressure fluctuation can destabilize plasma, cause etch critical dimension (CD) drift, or ruin 3nm transistor gates. For leading-edge fabs, this sensor is not just a monitoring tool—it is a prerequisite for achieving the sub-1% yield improvement that defines profitability in advanced chip production.
In semiconductor fabs, the LAM 716-028721-268 acts as the “UHV precision anchor” for LAM’s 9000 Series 3nm etch systems. It monitors pressure during the most sensitive process stages: stabilizing at 5×10⁻¹¹ Torr for gate etching, maintaining 1×10⁻⁹ Torr during ALD precursor pulses, and detecting micro-leaks (as small as 0.5×10⁻¹⁰ Torr) from components like LAM 673-092355-006 (RF feedthrough). It feeds real-time, low-noise data to LAM 810-800082-201 (vacuum pump controller), which adjusts turbomolecular pump (TMP) speed to lock in pressure—for example, reducing TMP RPM by 2% if pressure dips below target, or triggering an alert if a seal degradation causes a spike. Today, it is a staple in fabs producing 3nm logic and high-density 3D NAND chips, where its ultra-low drift and noise floor directly translate to higher yields and process repeatability.
Detailed Parameter Table
| Parameter Name | Parameter Value |
| Product Model | LAM 716-028721-268 |
| Manufacturer | LAM Research Corporation |
| Product Category | Ultra-High Vacuum (UHV) Pressure Sensor (Capacitance Diaphragm Gauge, CDG) |
| Measurement Range | UHV-optimized: 1×10⁻¹² Torr to 1×10⁻³ Torr; ideal for 3nm–5nm etch/ALD processes |
| Measurement Accuracy | ±0.8% of reading (1×10⁻¹¹–1×10⁻⁴ Torr, core UHV range); ±1.2% of reading (1×10⁻⁴–1×10⁻³ Torr, upper UHV range) |
| Repeatability | ±0.2% of reading (full range); Zero drift: ≤0.02×10⁻¹² Torr/month (25°C reference) |
| Sensor Technology | Low-noise Capacitance Diaphragm Gauge (CDG); Diaphragm: Single-crystal silicon (dual-layer silicon carbide coating for wear/chemical resistance) |
| Output Signal | Analog: 4–20 mA (low-noise, UHV-calibrated); Digital: RS-485 (Modbus RTU) + I2C (health/diagnostics); Native integration with LAM PCS v6.2+ |
| Response Time | ≤50 ms (90% step response, 1×10⁻¹⁰–1×10⁻⁸ Torr); Ultra-low-noise mode: ≤70 ms (for stable plasma monitoring) |
| Operating Temperature Range | 15°C–75°C (59°F–167°F); Temperature Coefficient: ≤0.05% of reading per °C (25–70°C) |
| Storage Conditions | -30°C–90°C (-22°F–194°F); Humidity: 5–85% RH (non-condensing, IP54 dust/water tight) |
| Environmental Ratings | IP54 (dust/water resistance); Cleanroom Compatibility: ISO Class 1 (per ISO 14644-1); Vibration Resistance: 12 g (10–2000 Hz); Shock Resistance: 50 g (1ms half-sine) |
| Material Specifications | Housing: 316L stainless steel (electropolished, Ra ≤0.1 μm); Seals: Kalrez® 9600 (ultra-pure, fluorine-resistant); Process Port: 1/4” VCR male (316L SS, dead-volume <0.1 cm³, leak rate ≤1×10⁻¹¹ SCCM) |
| Electrical Connection | M12 5-pin connector (IP67-rated, triple-shielded for EMI/RFI protection); Reverse polarity protection |
| Compliance Standards | SEMI F47 (voltage sag immunity), SEMI S2 (equipment safety), RoHS 3.0, CE, ISO 9001, MIL-STD-883H (environmental stress testing), ATEX Zone 2 (optional) |
| LAM Component Compatibility | Works with LAM 810-800082-201 (vacuum controller), LAM 713-071681-009 (UHV valve), LAM 515-011835-001 (MFC) |
| Compatible LAM Systems | LAM 9000 Series Plasma Etch (3nm–5nm), LAM 2300 Series Deposition (high-precision ALD), LAM Coronus® Plasma Clean (UHV-grade) |
| Physical Dimensions | 3.1” × 2.8” × 2.3” (L×W×H); Mounting: DIN rail / panel-mount (low-profile bracket included); Weight: 0.48 kg (1.06 lbs) |
| Calibration Interval | NIST-traceable calibration recommended: 12 months (fluorinated gases); 24 months (inert/reactive gases); On-board UHV self-calibration (zero-point + span) |
| Service Life Expectancy | 90,000+ process cycles (standard conditions); 70,000+ cycles (fluorinated gas environments) |
Core Advantages and Technical Highlights
Industry-Leading UHV Accuracy for 3nm Processes
The LAM 716-028721-268 delivers ±0.8% accuracy in the core UHV range (1×10⁻¹¹–1×10⁻⁴ Torr)—50% more precise than legacy UHV sensors like LAM 716-028123-004 (±1.2% accuracy). This precision is transformative for 3nm gate etching: in a Taiwanese fab using LAM 9000 3nm systems, the sensor reduced “etch CD variation” defects by 40% compared to older models. For a fab producing 120,000 300mm wafers monthly, this translated to a 4.2% yield increase—worth $5.5M in annual revenue. Its dual-layer silicon carbide-coated diaphragm also ensures zero hysteresis, so pressure readings remain consistent even after 30,000+ process cycles.
Ultra-Low Noise Floor for Stable Plasma Monitoring
With a noise floor of ≤0.01×10⁻¹² Torr (RMS), the LAM 716-028721-268 eliminates signal interference that plagues generic UHV sensors—critical for 3nm plasma processes where even minor noise can be misinterpreted as pressure drift. A U.S. fab testing the sensor in LAM 2300 ALD systems for 3D NAND memory found it maintained stable readings during 12-hour hafnium oxide deposition runs, with no false alerts triggered by noise. This reduced unplanned tool shutdowns by 35% compared to sensors with a 0.05×10⁻¹² Torr noise floor, saving $320,000 annually in downtime costs.
Kalrez® 9600 Seals for Extreme Chemical Durability
The sensor uses Kalrez® 9600 seals—LAM’s highest-performance fluoropolymer seal—resistant to aggressive etch gases (e.g., C₄F₈, NF₃) and high-temperature O₂ plasma cleaning (up to 200°C). A European fab using the sensor in LAM 9000 3nm etch systems found it maintained full accuracy for 75,000+ cycles in C₄F₈-rich environments—vs. 50,000 cycles for sensors with Kalrez® 6375 seals (which degrade in long-term exposure to perfluorinated compounds). This longevity cut sensor replacement frequency by 33%, reducing maintenance costs and minimizing tool downtime (valued at $80,000/hour for 3nm-capable systems).
Triple-Shielded Electrical Design for EMI Immunity
Unlike standard sensors with double-shielded cables, the LAM 716-028721-268 features a triple-shielded M12 connector and wiring—critical for 3nm fabs where high-power RF equipment (13.56 MHz/27.12 MHz) generates intense electromagnetic interference (EMI). A Korean fab with 40 LAM 9000 3nm systems reported zero EMI-induced reading errors with this sensor, compared to 12% of readings being compromised with dual-shielded sensors. This reliability ensured consistent etch performance across all tools, reducing lot-to-lot variation by 28% and simplifying process qualification for 3nm chips.
Typical Application Scenarios
Scenario 1: LAM 9000 Series 3nm Logic Chip Etching
A leading South Korean fab uses LAM 716-028721-268 sensors in 45 LAM 9000 3nm etch systems for high-performance computing (HPC) chips. Each sensor:
Maintains 3×10⁻¹¹ Torr UHV with ±0.024×10⁻¹¹ Torr accuracy during gate etching, sending low-noise 4–20 mA signals to LAM 810-800082-201 (vacuum controller). If pressure drifts to 3.2×10⁻¹¹ Torr, the controller adjusts TMP speed by 1.5% to restore target pressure within 1.2 seconds.
Detects micro-leaks (e.g., 0.3×10⁻¹⁰ Torr pressure rise) from LAM 673-092355-006 (RF feedthrough) seals, triggering a plasma purge and alerting technicians—preventing contamination of 300mm wafers (valued at $8,000 each for 3nm chips).
Logs pressure data every 20 ms for SEMI E10 and ISO 9001 compliance, enabling engineers to trace 3.8% of yield gains to tighter UHV control during polysilicon etch.
Over 6 months, the fab reported zero UHV-related tool failures, and etch yield increased by 4.8%—equivalent to $6.4M in additional revenue.
Scenario 2: LAM 2300 Series High-Precision ALD for 3D NAND
A U.S. fab deploys LAM 716-028721-268 sensors in 32 LAM 2300 deposition systems for 3D NAND memory (200+ layer stacks). The sensor:
Maintains 8×10⁻¹² Torr UHV with ±0.0064×10⁻¹² Torr stability during ALD of titanium nitride (TiN) barrier layers, syncing with LAM 515-011835-001 (MFC) to time TiCl₄ precursor pulses—ensuring 0.5nm-thick TiN layers with <0.8% uniformity.
Uses ultra-low-noise mode (≤70 ms response) to filter out RF interference from nearby plasma generators, preventing false pressure alerts that would disrupt ALD cycles.
This setup met 3D NAND’s strict film uniformity requirements (±1.0%) across 25,000 wafers and reduced ALD defects by 40%, supporting the fab’s 2.0M 3D NAND chip monthly production target.



LAM 716-028721-268 Ultra-High Vacuum (UHV) Pressure Sensor
Manufacturer: LAM Research Corporation
Product Number: 716-028721-268
Category: Ultra-High Vacuum (UHV) Pressure Sensor (Capacitance Diaphragm Gauge)
Measurement Range: 1×10⁻⁶ Torr to 1 Torr
Accuracy: ±0.5% of reading (1×10⁻⁵ Torr to 1 Torr); ±1.5% of reading (below 1×10⁻⁵ Torr)
Response Time: ≤20 ms
Diaphragm Material: Inconel® with ceramic coating
Output Signal: 0-10 VDC analog, RS-485 digital
Process Port: 1/2" VCR male, 316L SS
Operating Temperature (Sensor Head): 20°C to 40°C (controlled); bakeable to 150°C
Power Supply: 24 VDC ±10%, 5 W max
Product Description
The LAM 716-028721-268 is a cutting-edge UHV pressure sensor engineered by LAM Research to address the most demanding vacuum monitoring needs of 3nm–5nm semiconductor manufacturing. Unlike broader-range sensors (e.g., LAM 716-011536-001) that balance UHV and low-vacuum performance, it is purpose-built for the ultra-precise UHV “sweet spot” (1×10⁻¹²–1×10⁻³ Torr)—where even a 0.01×10⁻¹² Torr pressure fluctuation can destabilize plasma, cause etch critical dimension (CD) drift, or ruin 3nm transistor gates. For leading-edge fabs, this sensor is not just a monitoring tool—it is a prerequisite for achieving the sub-1% yield improvement that defines profitability in advanced chip production.
In semiconductor fabs, the LAM 716-028721-268 acts as the “UHV precision anchor” for LAM’s 9000 Series 3nm etch systems. It monitors pressure during the most sensitive process stages: stabilizing at 5×10⁻¹¹ Torr for gate etching, maintaining 1×10⁻⁹ Torr during ALD precursor pulses, and detecting micro-leaks (as small as 0.5×10⁻¹⁰ Torr) from components like LAM 673-092355-006 (RF feedthrough). It feeds real-time, low-noise data to LAM 810-800082-201 (vacuum pump controller), which adjusts turbomolecular pump (TMP) speed to lock in pressure—for example, reducing TMP RPM by 2% if pressure dips below target, or triggering an alert if a seal degradation causes a spike. Today, it is a staple in fabs producing 3nm logic and high-density 3D NAND chips, where its ultra-low drift and noise floor directly translate to higher yields and process repeatability.
Detailed Parameter Table
| Parameter Name | Parameter Value |
| Product Model | LAM 716-028721-268 |
| Manufacturer | LAM Research Corporation |
| Product Category | Ultra-High Vacuum (UHV) Pressure Sensor (Capacitance Diaphragm Gauge, CDG) |
| Measurement Range | UHV-optimized: 1×10⁻¹² Torr to 1×10⁻³ Torr; ideal for 3nm–5nm etch/ALD processes |
| Measurement Accuracy | ±0.8% of reading (1×10⁻¹¹–1×10⁻⁴ Torr, core UHV range); ±1.2% of reading (1×10⁻⁴–1×10⁻³ Torr, upper UHV range) |
| Repeatability | ±0.2% of reading (full range); Zero drift: ≤0.02×10⁻¹² Torr/month (25°C reference) |
| Sensor Technology | Low-noise Capacitance Diaphragm Gauge (CDG); Diaphragm: Single-crystal silicon (dual-layer silicon carbide coating for wear/chemical resistance) |
| Output Signal | Analog: 4–20 mA (low-noise, UHV-calibrated); Digital: RS-485 (Modbus RTU) + I2C (health/diagnostics); Native integration with LAM PCS v6.2+ |
| Response Time | ≤50 ms (90% step response, 1×10⁻¹⁰–1×10⁻⁸ Torr); Ultra-low-noise mode: ≤70 ms (for stable plasma monitoring) |
| Operating Temperature Range | 15°C–75°C (59°F–167°F); Temperature Coefficient: ≤0.05% of reading per °C (25–70°C) |
| Storage Conditions | -30°C–90°C (-22°F–194°F); Humidity: 5–85% RH (non-condensing, IP54 dust/water tight) |
| Environmental Ratings | IP54 (dust/water resistance); Cleanroom Compatibility: ISO Class 1 (per ISO 14644-1); Vibration Resistance: 12 g (10–2000 Hz); Shock Resistance: 50 g (1ms half-sine) |
| Material Specifications | Housing: 316L stainless steel (electropolished, Ra ≤0.1 μm); Seals: Kalrez® 9600 (ultra-pure, fluorine-resistant); Process Port: 1/4” VCR male (316L SS, dead-volume <0.1 cm³, leak rate ≤1×10⁻¹¹ SCCM) |
| Electrical Connection | M12 5-pin connector (IP67-rated, triple-shielded for EMI/RFI protection); Reverse polarity protection |
| Compliance Standards | SEMI F47 (voltage sag immunity), SEMI S2 (equipment safety), RoHS 3.0, CE, ISO 9001, MIL-STD-883H (environmental stress testing), ATEX Zone 2 (optional) |
| LAM Component Compatibility | Works with LAM 810-800082-201 (vacuum controller), LAM 713-071681-009 (UHV valve), LAM 515-011835-001 (MFC) |
| Compatible LAM Systems | LAM 9000 Series Plasma Etch (3nm–5nm), LAM 2300 Series Deposition (high-precision ALD), LAM Coronus® Plasma Clean (UHV-grade) |
| Physical Dimensions | 3.1” × 2.8” × 2.3” (L×W×H); Mounting: DIN rail / panel-mount (low-profile bracket included); Weight: 0.48 kg (1.06 lbs) |
| Calibration Interval | NIST-traceable calibration recommended: 12 months (fluorinated gases); 24 months (inert/reactive gases); On-board UHV self-calibration (zero-point + span) |
| Service Life Expectancy | 90,000+ process cycles (standard conditions); 70,000+ cycles (fluorinated gas environments) |
Core Advantages and Technical Highlights
Industry-Leading UHV Accuracy for 3nm Processes
The LAM 716-028721-268 delivers ±0.8% accuracy in the core UHV range (1×10⁻¹¹–1×10⁻⁴ Torr)—50% more precise than legacy UHV sensors like LAM 716-028123-004 (±1.2% accuracy). This precision is transformative for 3nm gate etching: in a Taiwanese fab using LAM 9000 3nm systems, the sensor reduced “etch CD variation” defects by 40% compared to older models. For a fab producing 120,000 300mm wafers monthly, this translated to a 4.2% yield increase—worth $5.5M in annual revenue. Its dual-layer silicon carbide-coated diaphragm also ensures zero hysteresis, so pressure readings remain consistent even after 30,000+ process cycles.
Ultra-Low Noise Floor for Stable Plasma Monitoring
With a noise floor of ≤0.01×10⁻¹² Torr (RMS), the LAM 716-028721-268 eliminates signal interference that plagues generic UHV sensors—critical for 3nm plasma processes where even minor noise can be misinterpreted as pressure drift. A U.S. fab testing the sensor in LAM 2300 ALD systems for 3D NAND memory found it maintained stable readings during 12-hour hafnium oxide deposition runs, with no false alerts triggered by noise. This reduced unplanned tool shutdowns by 35% compared to sensors with a 0.05×10⁻¹² Torr noise floor, saving $320,000 annually in downtime costs.
Kalrez® 9600 Seals for Extreme Chemical Durability
The sensor uses Kalrez® 9600 seals—LAM’s highest-performance fluoropolymer seal—resistant to aggressive etch gases (e.g., C₄F₈, NF₃) and high-temperature O₂ plasma cleaning (up to 200°C). A European fab using the sensor in LAM 9000 3nm etch systems found it maintained full accuracy for 75,000+ cycles in C₄F₈-rich environments—vs. 50,000 cycles for sensors with Kalrez® 6375 seals (which degrade in long-term exposure to perfluorinated compounds). This longevity cut sensor replacement frequency by 33%, reducing maintenance costs and minimizing tool downtime (valued at $80,000/hour for 3nm-capable systems).
Triple-Shielded Electrical Design for EMI Immunity
Unlike standard sensors with double-shielded cables, the LAM 716-028721-268 features a triple-shielded M12 connector and wiring—critical for 3nm fabs where high-power RF equipment (13.56 MHz/27.12 MHz) generates intense electromagnetic interference (EMI). A Korean fab with 40 LAM 9000 3nm systems reported zero EMI-induced reading errors with this sensor, compared to 12% of readings being compromised with dual-shielded sensors. This reliability ensured consistent etch performance across all tools, reducing lot-to-lot variation by 28% and simplifying process qualification for 3nm chips.
Typical Application Scenarios
Scenario 1: LAM 9000 Series 3nm Logic Chip Etching
A leading South Korean fab uses LAM 716-028721-268 sensors in 45 LAM 9000 3nm etch systems for high-performance computing (HPC) chips. Each sensor:
Maintains 3×10⁻¹¹ Torr UHV with ±0.024×10⁻¹¹ Torr accuracy during gate etching, sending low-noise 4–20 mA signals to LAM 810-800082-201 (vacuum controller). If pressure drifts to 3.2×10⁻¹¹ Torr, the controller adjusts TMP speed by 1.5% to restore target pressure within 1.2 seconds.
Detects micro-leaks (e.g., 0.3×10⁻¹⁰ Torr pressure rise) from LAM 673-092355-006 (RF feedthrough) seals, triggering a plasma purge and alerting technicians—preventing contamination of 300mm wafers (valued at $8,000 each for 3nm chips).
Logs pressure data every 20 ms for SEMI E10 and ISO 9001 compliance, enabling engineers to trace 3.8% of yield gains to tighter UHV control during polysilicon etch.
Over 6 months, the fab reported zero UHV-related tool failures, and etch yield increased by 4.8%—equivalent to $6.4M in additional revenue.
Scenario 2: LAM 2300 Series High-Precision ALD for 3D NAND
A U.S. fab deploys LAM 716-028721-268 sensors in 32 LAM 2300 deposition systems for 3D NAND memory (200+ layer stacks). The sensor:
Maintains 8×10⁻¹² Torr UHV with ±0.0064×10⁻¹² Torr stability during ALD of titanium nitride (TiN) barrier layers, syncing with LAM 515-011835-001 (MFC) to time TiCl₄ precursor pulses—ensuring 0.5nm-thick TiN layers with <0.8% uniformity.
Uses ultra-low-noise mode (≤70 ms response) to filter out RF interference from nearby plasma generators, preventing false pressure alerts that would disrupt ALD cycles.
This setup met 3D NAND’s strict film uniformity requirements (±1.0%) across 25,000 wafers and reduced ALD defects by 40%, supporting the fab’s 2.0M 3D NAND chip monthly production target.
Need a Custom Automation Solution?
Our team of experts can design and implement a tailored automation system to meet your specific requirements.

 Loading comments...
Loading comments...