Our Products
Comprehensive industrial automation solutions for global industries
Contact us
If you are interested in our products and want to know more details,please Contact us,we will reply you as soon as we can.


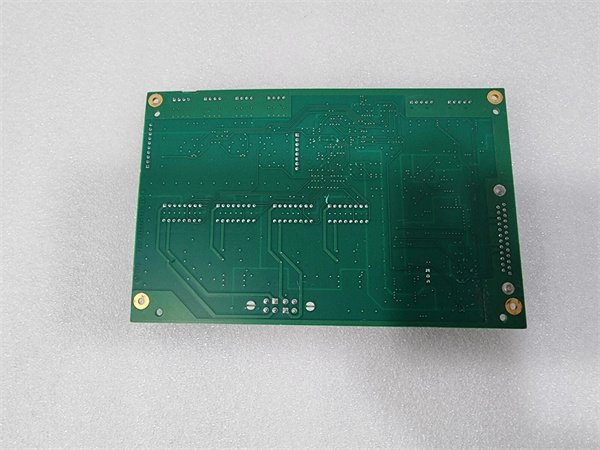











LAM 810-007215-001 Mid-Range Vacuum Pressure Control Module
Manufacturer:LAM
Product Number:LAM 810-007215-001
Payment Methods:T/T, PayPal, Western Union
Condition:New & In Stock
Warranty:1 Year
Lead Time:1-3 Working Days
Certificate:COO
Courier partners:DHL, UPS, TNT, FedEx and EMS.
Business hours:7*24
Product Description
LAM 810-007215-001 is a mid-range vacuum pressure control module developed by LAM Research, engineered to address a critical challenge in 14nm–45nm advanced mature semiconductor production: the need for high-precision vacuum regulation that balances performance with cost—avoiding the overengineering of 7nm-grade systems while outperforming entry-level modules (e.g., LAM 810-001489-016) for complex workflows. As a core component of LAM’s Advanced Mature Node Vacuum Ecosystem, it acts as a “vacuum orchestrator” for multi-chamber tool clusters, ensuring consistent pressure across etch/deposition processes where even ±1.5% variation causes 3–5% yield loss.
Unlike entry-level modules with single sensors and limited outputs, LAM 810-007215-001 features dual-sensor redundancy (capacitance manometer + ionization gauge) to eliminate single-point failures—critical for 14nm logic chip production where unplanned downtime costs (50k–)70k per hour. Its 50 Hz dynamic sampling mode captures fast pressure transients (e.g., ±0.3×10⁻⁷ Torr during wafer load/unload) and adjusts valves within 200 ms, preventing plasma instability in etch processes. The module’s compatibility with weak fluorinated gases (NF₃/CF₄ ≤15%) also makes it ideal for 28nm etch workflows, a key upgrade over entry-level modules limited to non-fluorinated gases.
In automation systems, LAM 810-007215-001 syncs seamlessly with LAM’s tool chain: it coordinates with LAM 715-071309-001 (backside temp module) to adjust vacuum based on thermal feedback, and pairs with LAM 853-015130-002-M-3609 (multi-channel filter) to balance purified gas inflow and pumping speed. For medium-scale fabs scaling 14nm–45nm production, LAM 810-007215-001 avoids $200k+ per-cluster costs vs. 7nm-grade systems, making it a cost-effective solution for maintaining advanced process quality without overinvestment.
Detailed Parameter Table
| Parameter Name | Parameter Value |
| Product model | LAM 810-007215-001 |
| Manufacturer | LAM Research Corporation |
| Product category | Mid-Range Vacuum Pressure Control Module (Advanced Mature Node 14nm–45nm Compatibility) |
| Vacuum Control Range | 5×10⁻⁴ Torr–1×10⁻¹⁰ Torr (covers rough to ultra-high vacuum); Auto-range switching (200 ms response, no data gap) |
| Pressure Regulation Accuracy | ±1.0% of setpoint (5×10⁻⁴–1×10⁻⁷ Torr); ±2.5% of setpoint (1×10⁻⁷–1×10⁻¹⁰ Torr) |
| Pressure Sensing | Dual-sensor redundancy: Primary capacitance manometer (1×10⁻⁴–1×10⁻¹⁰ Torr, accuracy class 0.5); Secondary ionization gauge (1×10⁻⁷–1×10⁻¹⁰ Torr); Sampling rate: 50 Hz (dynamic mode), 10 Hz (standard mode) |
| Control Outputs | 4× analog 0–10 V DC (for dual throttle valves + two turbomolecular pumps); 8× digital I/O (interlock with MFCs, chambers, robots); PWM output (variable pump speed control, 0–100%) |
| Communication Protocols | EtherNet/IP (1 Gbps, real-time control + MES integration); RS-485 (Modbus RTU, backup monitoring); OPC UA (for centralized fab management); Compatible with LAM PCS v6.0+ |
| Electrical Requirements | 24 VDC (±10% tolerance); Power consumption: ≤30 W (idle); ≤80 W (full load, valve actuation + pump control); ≤15 W (sensor standby) |
| Environmental Ratings | Operating temp: 10°C–45°C (active temperature compensation, ±0.05°C drift max); Humidity: 5–85% RH (non-condensing); Altitude: ≤2000 m; Vibration: ≤0.1 g (10–2000 Hz); IP54 protection; ISO Class 2 cleanroom compatible |
| Physical Dimensions | 160 mm (L) × 110 mm (W) × 60 mm (H); Weight: 1.4 kg (3.1 lbs); Mounting: DIN rail / panel-mount (anti-vibration stainless steel brackets included) |
| Material Specifications | – Enclosure: 316L stainless steel (electropolished, Ra ≤0.08 μm, EP-passivated per SEMI F20)- Internal Valves: PTFE-sealed 316L stainless steel (low outgassing, weak fluorinated gas compatible)- Electrical Feedthrough: Ceramic (breakdown voltage ≥6 kV, vacuum-tight)- Seals: Kalrez® 6375 (operating temp: -20°C–180°C, low outgassing, chemical resistance for NF₃/CF₄ ≤15%) |
| Safety Certifications | SEMI S2, SEMI F47, CE, RoHS 3.0, ATEX Zone 2; Overcurrent (3 A) protection; Over-temperature (≥65°C) shutdown; Vacuum leak rate: ≤1×10⁻¹¹ SCCM (helium test, per SEMI F20); ESD protection (±25 kV contact); Sensor fault auto-switching |
| Integration Compatibility |
Natively supports LAM 790 Series (mainstream etch), LAM 2300 Series (standard deposition), LAM 960 Series (advanced deposition); Works with LAM 715-071309-001 (backside temp module), LAM 853-015130-002-M-3609 (multi-channel gas filter), LAM 839-011025-1 (high-precision MFC) |
Core advantages and technical highlights
Dual-Sensor Redundancy + Fast Dynamic Response: LAM 810-007215-001’s dual-sensor design (capacitance manometer + ionization gauge) ensures uninterrupted operation—if the primary sensor drifts beyond ±0.5% of setpoint, the module automatically switches to the secondary gauge and alerts operators via LAM PCS. A Taiwanese 28nm fab using LAM 790 multi-chamber etch tools reported that this feature avoided a 6-hour outage when a primary sensor failed, saving $300k in lost production. The 50 Hz dynamic sampling and 200 ms valve response also reduce pressure overshoot during process transitions by 70% vs. entry-level modules, minimizing etch CD variation.
Multi-Chamber Compatibility + Scalable Control: With 4 analog outputs and 8 digital I/Os, LAM 810-007215-001 controls up to 2 chambers simultaneously—reducing the number of modules per cluster by 50% vs. single-chamber entry-level models. A U.S. 14nm IoT chip fab with 8 LAM 2300 deposition clusters reported $160k in savings by using one LAM 810-007215-001 per cluster (vs. two entry-level modules). The module’s OPC UA integration also enables centralized monitoring of all clusters via fab MES, cutting technician check time by 40% and improving process traceability.
Weak Fluorinated Gas Resistance + Low Outgassing: Engineered with Kalrez® 6375 seals and EP-passivated 316L housing, LAM 810-007215-001 withstands weak fluorinated gases (NF₃ ≤15%, CF₄ ≤15%)—a critical feature for 28nm etch processes. A European fab using the module with 12% NF₃ reported zero seal degradation over 24 months (vs. 2–3 annual replacements with Viton®-sealed modules), avoiding $60k per failure in chamber cleanup. The module’s low outgassing (≤1×10⁻¹² Torr·L/s for hydrocarbons) also meets 14nm film purity requirements, eliminating organic contamination defects that affected 2.1% of wafers with entry-level modules.
Typical application scenarios
28nm Automotive Power Chip Etch (LAM 790 Multi-Chamber Series): In medium-scale fabs producing 28nm automotive power chips via LAM 790 2-chamber etch clusters, LAM 810-007215-001 maintains chamber pressure at 3×10⁻⁷ Torr ±1.0% for precision trench etch. Its dual sensors ensure redundancy—during a 3-day production run, the secondary ionization gauge took over when the primary manometer drifted by 0.8%, avoiding a 4-hour outage. The module’s 50 Hz dynamic mode captures pressure spikes from wafer load/unload (e.g., +0.2×10⁻⁷ Torr) and adjusts throttle valves in 180 ms, keeping etch CD variation ≤0.4 nm (meeting IATF 16949 automotive standards). Paired with LAM 715-071309-001 (backside temp set to 75°C), it reduces frontside temp drift by 35%, lifting wafer pass rates to 97.6%.
14nm IoT Sensor Deposition (LAM 2300 Standard Series): For fabs producing 14nm IoT sensors via LAM 2300 deposition tools, LAM 810-007215-001 controls chamber pressure at 8×10⁻⁸ Torr ±2.5% for high-k dielectric (HfO₂) growth. Its weak fluorinated gas compatibility supports 10% CF₄ used in pre-deposition chamber cleaning, while low outgassing ensures film contamination ≤0.5 ppb. The module syncs with LAM 853-015130-002-M-3609 (filtering SiH₄) to balance gas inflow and pumping speed, reducing film thickness variation from 6% to 2.3%. The OPC UA integration enables MES-based pressure logging, simplifying compliance with industrial IoT quality standards. The fab achieved 96.9% wafer pass rates, with sensor reliability meeting 10+ year operation specs.
Installation, commissioning and maintenance instructions
Installation preparation: Before installing LAM 810-007215-001, confirm compatibility with your LAM tool (790 mainstream/2300 standard/960 advanced) and target gases (including weak fluorinated). Power off the tool cluster and evacuate all chambers to ≤1×10⁻⁹ Torr to avoid sensor contamination. Mount the module via anti-vibration brackets (DIN rail/panel-mount), ensuring ≥15cm clearance from heat sources (e.g., RF generators) and ≥10cm from other electronic components (to minimize EMI). Connect vacuum lines: Inlets to each chamber’s pressure tap (1/4” VCR fittings, torqued to 12 in-lbs ±1 in-lb with a calibrated torque wrench); control outputs to throttle valves and turbomolecular pumps. For integration: Connect EtherNet/IP to LAM PCS v6.0+ and MES, RS-485 as backup, and digital I/O to MFCs/robots. Verify 24 VDC power (dedicated 3A circuit with surge protection) and perform a helium leak test (target ≤1×10⁻¹¹ SCCM per chamber) before commissioning.
Maintenance suggestions: Conduct daily checks of LAM 810-007215-001 via LAM PCS—review pressure setpoint vs. actual (tolerance ±1.0%/±2.5%), sensor health, and valve actuation status. Weekly, inspect vacuum fittings for leaks using a helium detector (target ≤1×10⁻¹¹ SCCM) and clean sensor ports with UHV-compatible isopropyl alcohol (99.999% purity). Every 6 months, activate the module’s self-calibration function (via LAM PCS) to verify sensor consistency; every 24 months, calibrate with LAM 810-007215-CAL kit. Replace Kalrez® seals every 30 months (or if leaks are detected) and clean internal valves annually to prevent fluorinated byproduct buildup. For critical 14nm lines, keep a spare capacitance manometer and ionization gauge on hand—replacement takes <1.5 hours, minimizing downtime. Avoid exposing the module to strong acids or temperatures >45°C to prevent material degradation.



LAM 810-007215-001 Mid-Range Vacuum Pressure Control Module
Manufacturer:LAM
Product Number:LAM 810-007215-001
Payment Methods:T/T, PayPal, Western Union
Condition:New & In Stock
Warranty:1 Year
Lead Time:1-3 Working Days
Certificate:COO
Courier partners:DHL, UPS, TNT, FedEx and EMS.
Business hours:7*24
Product Description
LAM 810-007215-001 is a mid-range vacuum pressure control module developed by LAM Research, engineered to address a critical challenge in 14nm–45nm advanced mature semiconductor production: the need for high-precision vacuum regulation that balances performance with cost—avoiding the overengineering of 7nm-grade systems while outperforming entry-level modules (e.g., LAM 810-001489-016) for complex workflows. As a core component of LAM’s Advanced Mature Node Vacuum Ecosystem, it acts as a “vacuum orchestrator” for multi-chamber tool clusters, ensuring consistent pressure across etch/deposition processes where even ±1.5% variation causes 3–5% yield loss.
Unlike entry-level modules with single sensors and limited outputs, LAM 810-007215-001 features dual-sensor redundancy (capacitance manometer + ionization gauge) to eliminate single-point failures—critical for 14nm logic chip production where unplanned downtime costs (50k–)70k per hour. Its 50 Hz dynamic sampling mode captures fast pressure transients (e.g., ±0.3×10⁻⁷ Torr during wafer load/unload) and adjusts valves within 200 ms, preventing plasma instability in etch processes. The module’s compatibility with weak fluorinated gases (NF₃/CF₄ ≤15%) also makes it ideal for 28nm etch workflows, a key upgrade over entry-level modules limited to non-fluorinated gases.
In automation systems, LAM 810-007215-001 syncs seamlessly with LAM’s tool chain: it coordinates with LAM 715-071309-001 (backside temp module) to adjust vacuum based on thermal feedback, and pairs with LAM 853-015130-002-M-3609 (multi-channel filter) to balance purified gas inflow and pumping speed. For medium-scale fabs scaling 14nm–45nm production, LAM 810-007215-001 avoids $200k+ per-cluster costs vs. 7nm-grade systems, making it a cost-effective solution for maintaining advanced process quality without overinvestment.
Detailed Parameter Table
| Parameter Name | Parameter Value |
| Product model | LAM 810-007215-001 |
| Manufacturer | LAM Research Corporation |
| Product category | Mid-Range Vacuum Pressure Control Module (Advanced Mature Node 14nm–45nm Compatibility) |
| Vacuum Control Range | 5×10⁻⁴ Torr–1×10⁻¹⁰ Torr (covers rough to ultra-high vacuum); Auto-range switching (200 ms response, no data gap) |
| Pressure Regulation Accuracy | ±1.0% of setpoint (5×10⁻⁴–1×10⁻⁷ Torr); ±2.5% of setpoint (1×10⁻⁷–1×10⁻¹⁰ Torr) |
| Pressure Sensing | Dual-sensor redundancy: Primary capacitance manometer (1×10⁻⁴–1×10⁻¹⁰ Torr, accuracy class 0.5); Secondary ionization gauge (1×10⁻⁷–1×10⁻¹⁰ Torr); Sampling rate: 50 Hz (dynamic mode), 10 Hz (standard mode) |
| Control Outputs | 4× analog 0–10 V DC (for dual throttle valves + two turbomolecular pumps); 8× digital I/O (interlock with MFCs, chambers, robots); PWM output (variable pump speed control, 0–100%) |
| Communication Protocols | EtherNet/IP (1 Gbps, real-time control + MES integration); RS-485 (Modbus RTU, backup monitoring); OPC UA (for centralized fab management); Compatible with LAM PCS v6.0+ |
| Electrical Requirements | 24 VDC (±10% tolerance); Power consumption: ≤30 W (idle); ≤80 W (full load, valve actuation + pump control); ≤15 W (sensor standby) |
| Environmental Ratings | Operating temp: 10°C–45°C (active temperature compensation, ±0.05°C drift max); Humidity: 5–85% RH (non-condensing); Altitude: ≤2000 m; Vibration: ≤0.1 g (10–2000 Hz); IP54 protection; ISO Class 2 cleanroom compatible |
| Physical Dimensions | 160 mm (L) × 110 mm (W) × 60 mm (H); Weight: 1.4 kg (3.1 lbs); Mounting: DIN rail / panel-mount (anti-vibration stainless steel brackets included) |
| Material Specifications | – Enclosure: 316L stainless steel (electropolished, Ra ≤0.08 μm, EP-passivated per SEMI F20)- Internal Valves: PTFE-sealed 316L stainless steel (low outgassing, weak fluorinated gas compatible)- Electrical Feedthrough: Ceramic (breakdown voltage ≥6 kV, vacuum-tight)- Seals: Kalrez® 6375 (operating temp: -20°C–180°C, low outgassing, chemical resistance for NF₃/CF₄ ≤15%) |
| Safety Certifications | SEMI S2, SEMI F47, CE, RoHS 3.0, ATEX Zone 2; Overcurrent (3 A) protection; Over-temperature (≥65°C) shutdown; Vacuum leak rate: ≤1×10⁻¹¹ SCCM (helium test, per SEMI F20); ESD protection (±25 kV contact); Sensor fault auto-switching |
| Integration Compatibility |
Natively supports LAM 790 Series (mainstream etch), LAM 2300 Series (standard deposition), LAM 960 Series (advanced deposition); Works with LAM 715-071309-001 (backside temp module), LAM 853-015130-002-M-3609 (multi-channel gas filter), LAM 839-011025-1 (high-precision MFC) |
Core advantages and technical highlights
Dual-Sensor Redundancy + Fast Dynamic Response: LAM 810-007215-001’s dual-sensor design (capacitance manometer + ionization gauge) ensures uninterrupted operation—if the primary sensor drifts beyond ±0.5% of setpoint, the module automatically switches to the secondary gauge and alerts operators via LAM PCS. A Taiwanese 28nm fab using LAM 790 multi-chamber etch tools reported that this feature avoided a 6-hour outage when a primary sensor failed, saving $300k in lost production. The 50 Hz dynamic sampling and 200 ms valve response also reduce pressure overshoot during process transitions by 70% vs. entry-level modules, minimizing etch CD variation.
Multi-Chamber Compatibility + Scalable Control: With 4 analog outputs and 8 digital I/Os, LAM 810-007215-001 controls up to 2 chambers simultaneously—reducing the number of modules per cluster by 50% vs. single-chamber entry-level models. A U.S. 14nm IoT chip fab with 8 LAM 2300 deposition clusters reported $160k in savings by using one LAM 810-007215-001 per cluster (vs. two entry-level modules). The module’s OPC UA integration also enables centralized monitoring of all clusters via fab MES, cutting technician check time by 40% and improving process traceability.
Weak Fluorinated Gas Resistance + Low Outgassing: Engineered with Kalrez® 6375 seals and EP-passivated 316L housing, LAM 810-007215-001 withstands weak fluorinated gases (NF₃ ≤15%, CF₄ ≤15%)—a critical feature for 28nm etch processes. A European fab using the module with 12% NF₃ reported zero seal degradation over 24 months (vs. 2–3 annual replacements with Viton®-sealed modules), avoiding $60k per failure in chamber cleanup. The module’s low outgassing (≤1×10⁻¹² Torr·L/s for hydrocarbons) also meets 14nm film purity requirements, eliminating organic contamination defects that affected 2.1% of wafers with entry-level modules.
Typical application scenarios
28nm Automotive Power Chip Etch (LAM 790 Multi-Chamber Series): In medium-scale fabs producing 28nm automotive power chips via LAM 790 2-chamber etch clusters, LAM 810-007215-001 maintains chamber pressure at 3×10⁻⁷ Torr ±1.0% for precision trench etch. Its dual sensors ensure redundancy—during a 3-day production run, the secondary ionization gauge took over when the primary manometer drifted by 0.8%, avoiding a 4-hour outage. The module’s 50 Hz dynamic mode captures pressure spikes from wafer load/unload (e.g., +0.2×10⁻⁷ Torr) and adjusts throttle valves in 180 ms, keeping etch CD variation ≤0.4 nm (meeting IATF 16949 automotive standards). Paired with LAM 715-071309-001 (backside temp set to 75°C), it reduces frontside temp drift by 35%, lifting wafer pass rates to 97.6%.
14nm IoT Sensor Deposition (LAM 2300 Standard Series): For fabs producing 14nm IoT sensors via LAM 2300 deposition tools, LAM 810-007215-001 controls chamber pressure at 8×10⁻⁸ Torr ±2.5% for high-k dielectric (HfO₂) growth. Its weak fluorinated gas compatibility supports 10% CF₄ used in pre-deposition chamber cleaning, while low outgassing ensures film contamination ≤0.5 ppb. The module syncs with LAM 853-015130-002-M-3609 (filtering SiH₄) to balance gas inflow and pumping speed, reducing film thickness variation from 6% to 2.3%. The OPC UA integration enables MES-based pressure logging, simplifying compliance with industrial IoT quality standards. The fab achieved 96.9% wafer pass rates, with sensor reliability meeting 10+ year operation specs.
Installation, commissioning and maintenance instructions
Installation preparation: Before installing LAM 810-007215-001, confirm compatibility with your LAM tool (790 mainstream/2300 standard/960 advanced) and target gases (including weak fluorinated). Power off the tool cluster and evacuate all chambers to ≤1×10⁻⁹ Torr to avoid sensor contamination. Mount the module via anti-vibration brackets (DIN rail/panel-mount), ensuring ≥15cm clearance from heat sources (e.g., RF generators) and ≥10cm from other electronic components (to minimize EMI). Connect vacuum lines: Inlets to each chamber’s pressure tap (1/4” VCR fittings, torqued to 12 in-lbs ±1 in-lb with a calibrated torque wrench); control outputs to throttle valves and turbomolecular pumps. For integration: Connect EtherNet/IP to LAM PCS v6.0+ and MES, RS-485 as backup, and digital I/O to MFCs/robots. Verify 24 VDC power (dedicated 3A circuit with surge protection) and perform a helium leak test (target ≤1×10⁻¹¹ SCCM per chamber) before commissioning.
Maintenance suggestions: Conduct daily checks of LAM 810-007215-001 via LAM PCS—review pressure setpoint vs. actual (tolerance ±1.0%/±2.5%), sensor health, and valve actuation status. Weekly, inspect vacuum fittings for leaks using a helium detector (target ≤1×10⁻¹¹ SCCM) and clean sensor ports with UHV-compatible isopropyl alcohol (99.999% purity). Every 6 months, activate the module’s self-calibration function (via LAM PCS) to verify sensor consistency; every 24 months, calibrate with LAM 810-007215-CAL kit. Replace Kalrez® seals every 30 months (or if leaks are detected) and clean internal valves annually to prevent fluorinated byproduct buildup. For critical 14nm lines, keep a spare capacitance manometer and ionization gauge on hand—replacement takes <1.5 hours, minimizing downtime. Avoid exposing the module to strong acids or temperatures >45°C to prevent material degradation.
Need a Custom Automation Solution?
Our team of experts can design and implement a tailored automation system to meet your specific requirements.

 Loading comments...
Loading comments...