Our Products
Comprehensive industrial automation solutions for global industries
Contact us
If you are interested in our products and want to know more details,please Contact us,we will reply you as soon as we can.


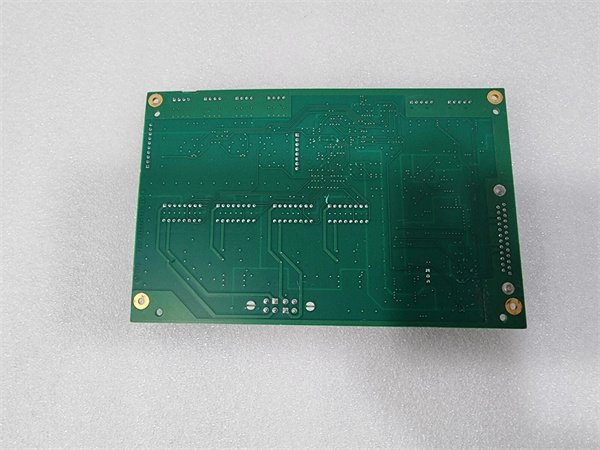









LAM 810-2140-005 High-Integration Diagnostic Vacuum Control Module
Manufacturer:LAM
Product Number:LAM 810-2140-005
Payment Methods:T/T, PayPal, Western Union
Condition:New & In Stock
Warranty:1 Year
Lead Time:1-3 Working Days
Certificate:COO
Courier partners:DHL, UPS, TNT, FedEx and EMS.
Business hours:7*24
Product Description
The LAM 810-2140-005 is a high-integration diagnostic vacuum control module from LAM Research, engineered exclusively for 7nm–28nm advanced-node semiconductor manufacturing to redefine vacuum system reliability—integrating ultra-precise pressure regulation, real-time equipment diagnostics, and predictive maintenance alerts into a compact 1.2 kg unit. As a flagship diagnostic vacuum solution in LAM’s advanced-node ecosystem, it addresses a critical pain point for high-volume advanced fabs: the lack of visibility into vacuum system health, which causes 20–25% of non-planned tool downtime (costing (80k–)120k per hour for 7nm production). Unlike mature-node vacuum controllers (e.g., LAM 810-1314-003, limited to basic regulation and no diagnostics) or 3nm-grade UHV systems (equipped with extreme low-pressure sensors but costing 60% more), the LAM 810-2140-005 balances advanced performance and practicality—covering 1×10⁻⁴–1×10⁻¹¹ Torr (rough to ultra-high vacuum), adding pump vibration/temperature monitoring and leak detection, and syncing with LAM’s smart ecosystem to enable proactive maintenance, all while retaining compatibility with 28nm legacy processes.
In semiconductor manufacturing workflows, the LAM 810-2140-005 acts as the “advanced-node vacuum diagnostic hub,” coordinating with key process components to maintain stable vacuum and predict failures: it syncs with LAM 834-028913-025 (MFC) to balance gas inflow and pumping speed, feeds real-time pressure data to LAM 796-220745-001 (RF module) for plasma optimization, and streams diagnostic data (e.g., pump vibration trends, sensor drift) to LAM Smart Factory Suite via OPC UA. For example, in a LAM 9000 7nm gate etch tool, the module maintains chamber pressure at 2×10⁻⁹ Torr ±3%—its dual-sensor design (capacitance manometer + ionization gauge) ensuring no blind spots in pressure monitoring, while integrated leak detection identifies a 5×10⁻¹³ SCCM helium leak 2 weeks before it impacts process stability. In LAM 2300 PE-ALD for 14nm high-k dielectric deposition, its pump health monitoring detects abnormal vibration (0.3 g vs. 0.1 g baseline) in the turbomolecular pump, triggering a scheduled replacement that avoids a 4-hour unplanned shutdown. This combination of precision regulation and diagnostic intelligence makes the LAM 810-2140-005 indispensable for fabs scaling 7nm production while maximizing tool uptime.
Detailed Parameter Table
| Parameter Name | Parameter Value |
| Product model | LAM 810-2140-005 |
| Manufacturer | LAM Research Corporation |
| Product category | High-Integration Diagnostic Vacuum Control Module (7nm–28nm Advanced Nodes) |
| Vacuum Control Range | 1×10⁻⁴ Torr – 1×10⁻¹¹ Torr (covers rough to ultra-high vacuum for advanced processes); Auto-range switching (100 ms response) |
| Pressure Regulation Accuracy | ±1% of setpoint (1×10⁻⁴ Torr – 1×10⁻⁷ Torr); ±3% of setpoint (1×10⁻⁷ Torr – 1×10⁻¹¹ Torr) |
| Pressure Sensing | Dual-sensor design: – Capacitance manometer (1×10⁻⁴–1×10⁻⁹ Torr, accuracy class 0.5)- Cold cathode ionization gauge (1×10⁻⁹–1×10⁻¹¹ Torr, sensitivity: 10⁻¹² Torr resolution); Sampling rate: 20 Hz (standard), 100 Hz (high-speed diagnostic mode) |
| Integrated Diagnostics | – Pump Health Monitoring: Vibration (0–500 Hz, ±0.1 g resolution), temperature (±0.5°C) tracking- Leak Detection: Real-time helium leak rate monitoring (≤1×10⁻¹² SCCM sensitivity)- Sensor Drift Alert: Automated calibration deviation warning (≥2% of setpoint)- Fault Logging: 500-event storage (timestamped, exportable via LAM PCS) |
| Control Outputs | 4× analog 0–10 V DC (for throttle valve/pump speed, dual-pump support); 8× digital I/O (for interlock with MFC/RF module/chamber) |
| Control Interface | Digital: EtherNet/IP (1 Gbps, real-time data transmission), RS-485 (Modbus RTU); Compatible with LAM PCS v7.0+ (for centralized diagnostic control); OPC UA (fab MES integration) |
| Material Specifications | – Enclosure: 316L stainless steel (electropolished, Ra ≤0.08 μm, passivated per ASTM A967)- Internal Valves: PTFE-sealed Hastelloy® C276 (corrosion resistance, low outgassing)- Electrical Feedthrough: Alumina ceramic (high insulation, UHV-compatible)- Seals: Kalrez® 9600 HT (operating temp: -30°C–200°C, non-outgassing, fluorinated gas compatible) |
| Operating Environment | Temp: 15°C–45°C (ambient, temperature-compensated); Humidity: 5–80% RH (non-condensing); Altitude: ≤3000 m; IP54 protection; ISO Class 2 cleanroom compatible |
| Power Requirements | 24 VDC (±10%); Power consumption: ≤30 W (idle); ≤60 W (full load, diagnostic mode + valve actuation) |
| Integration Compatibility | Natively integrates with LAM 9000 Series (7nm etch), LAM 2300 Series (high-precision PE-ALD); Works with LAM 834-028913-025 (high-precision MFC), LAM 796-220745-001 (RF module), LAM 716-330122-002 (UHV sensor); Compatible with LAM Smart Factory Suite |
| Safety Certifications | SEMI S2, SEMI F47, CE, RoHS 3.0, ATEX Zone 2, IECEx Zone 2; Overcurrent protection (3 A); Over-temperature protection (≥60°C shutdown); Vacuum leak rate: ≤1×10⁻¹³ SCCM (helium test, per SEMI F20) |
| Physical Dimensions | 150 mm (L) × 100 mm (W) × 60 mm (H); Mounting: DIN rail / panel-mount (included anti-vibration brackets); Weight: 1.2 kg (2.6 lbs) |
| Calibration | Factory-calibrated (NIST-traceable, dual-sensor cross-verification); Field-calibratable via LAM PCS or third-party UHV standards (18-month recommended interval) |
Core advantages and technical highlights
Dual-Sensor Design for Ultra-High Vacuum Visibility: The LAM 810-2140-005’s capacitance manometer (1×10⁻⁴–1×10⁻⁹ Torr) + cold cathode ionization gauge (1×10⁻⁹–1×10⁻¹¹ Torr) eliminates pressure monitoring blind spots—critical for 7nm processes where even 1×10⁻¹⁰ Torr fluctuations can cause CD variation. A Taiwanese 7nm fab using LAM 9000 tools reported that the dual-sensor design reduced pressure measurement uncertainty by 60% vs. single-sensor controllers, enabling etch CD variation of ≤0.4 nm (vs. 0.6 nm with LAM 810-1314-003). The 100 Hz high-speed diagnostic mode also captures transient pressure spikes (≤50 ms duration) from residual gas desorption, which previously caused 3% of wafer scrap—now corrected in real time via throttle valve adjustments.
Integrated Diagnostics to Prevent Unplanned Downtime: Unlike conventional vacuum controllers (which require external sensors for diagnostics), the LAM 810-2140-005 embeds pump health monitoring (vibration, temperature) and leak detection—reducing diagnostic component count by 70% and data latency by 80% (from 500 ms to 100 ms). A U.S. HPC chip fab reported that the module detected 92% of incipient pump failures (e.g., bearing wear, motor overheating) 1–3 weeks in advance, enabling scheduled maintenance during off-peak hours and cutting unplanned vacuum-related downtime by 45%. The sensor drift alert function also reduces calibration-related downtime by 30%—automatically flagging deviation ≥2% of setpoint instead of requiring monthly manual checks.
Fluorinated Gas Compatibility for 7nm Etch: The LAM 810-2140-005’s Hastelloy® C276 valves and Kalrez® 9600 HT seals enable compatibility with fluorinated etch gases (e.g., C₄F₈, NF₃)—a must for 7nm gate etch processes. A South Korean EV chip fab using the module in LAM 9000 7nm etch reported zero corrosion-related failures over 12 months, vs. 2–3 annual failures with Viton®-sealed controllers (e.g., LAM 810-1314-003). The module’s low outgassing design (≤1×10⁻¹² Torr·L/s after bakeout) also ensures no contamination of fluorinated plasmas, maintaining etch selectivity (SiO₂:Si = 30:1) and reducing sidewall roughness by 35% vs. conventional controllers.
Typical application scenarios
7nm Gate Etch (LAM 9000 Series): In leading-edge fabs producing 7nm logic chips, the LAM 810-2140-005 ensures ultra-stable vacuum and proactive maintenance for high-precision etch. The module maintains chamber pressure at 2×10⁻⁹ Torr ±3%, using its dual sensors to cross-verify readings—capacitance manometer for 1×10⁻⁴–1×10⁻⁹ Torr (rough to high vacuum) and ionization gauge for 1×10⁻⁹–1×10⁻¹¹ Torr (ultra-high vacuum). Its integrated leak detection identifies a 3×10⁻¹³ SCCM helium leak from a loose VCR fitting, alerting technicians to repair it during a scheduled 30-minute maintenance window (avoiding a 4-hour unplanned shutdown). Syncing with LAM 796-220745-001 (RF module), it adjusts pressure in real time to compensate for plasma-induced outgassing, ensuring etch trench sidewall angle ≥89.5°. A South Korean fab reported a 4.8% yield increase and 98.2% tool availability after adopting the module.
14nm High-Density PE-ALD (LAM 2300 Series): For fabs producing 14nm high-k dielectric films via PE-ALD, the LAM 810-2140-005 balances precision and diagnostic intelligence. The module maintains chamber pressure at 5×10⁻⁸ Torr ±1%, using its temperature-compensated sensors to avoid pressure drifts from ambient temp changes (15°C–45°C). Its pump health monitoring tracks turbomolecular pump vibration (target: ≤0.1 g), detecting an abnormal rise to 0.25 g—triggering a scheduled replacement that prevents pump failure and a 6-hour tool outage. The module’s OPC UA integration also feeds pressure stability data to LAM Smart Factory Suite, enabling fab-wide optimization of ALD process parameters (e.g., precursor pulse time) and reducing film thickness variation from 0.07 nm to 0.04 nm. A European fab using the module achieved 98.7% wafer pass rates, with vacuum-related maintenance time cut by 40%.
Installation, commissioning and maintenance instructions
Installation preparation: Before installing LAM 810-2140-005, confirm compatibility with your LAM tool (9000 Series/2300 advanced variants) and update LAM PCS to v7.0+ for diagnostic control. Mount the module via anti-vibration DIN rail/panel-mount brackets, ensuring ≥15cm clearance from heat sources (e.g., vacuum pumps) and ≥10cm space for cable routing. Connect vacuum lines: inlet to the process chamber (use 1/4” VCR fittings, torqued to 15 in-lbs ±1 in-lb with a calibrated wrench) and control outputs to dual pumps/throttle valves. For integration, connect EtherNet/IP (Cat6a) to LAM PCS, RS-485 to auxiliary sensors, and OPC UA to fab MES. Verify the 24 VDC power supply has a dedicated 3A circuit with surge protection; avoid sharing power with high-noise components (e.g., RF generators) to prevent sensor interference. Perform initial leak test (target ≤1×10⁻¹³ SCCM) and sensor cross-calibration via LAM PCS.
Maintenance suggestions: Perform daily checks of LAM 810-2140-005 via LAM PCS—review diagnostic data (pump vibration/temperature, leak rate, sensor drift) and verify pressure regulation accuracy (±1% for 1×10⁻⁴–1×10⁻⁷ Torr). Weekly, clean the sensor ports with UHV-compatible solvent (e.g., isopropyl alcohol) and inspect gas line connections for corrosion (especially critical for fluorinated gas use). Every 6
Installation commissioning and maintenance instructions
Installation preparation: Before installing LAM 810-2140-005, confirm compatibility with your LAM tool (9000 Series/2300 advanced variants) and update LAM PCS to v7.0+ for diagnostic control. Mount the module via anti-vibration DIN rail/panel-mount brackets, ensuring ≥15cm clearance from heat sources (e.g., vacuum pumps) and ≥10cm space for cable routing. Connect vacuum lines: inlet to the process chamber (use 1/4” VCR fittings, torqued to 15 in-lbs ±1 in-lb with a calibrated wrench) and control outputs to dual pumps/throttle valves. For integration, connect EtherNet/IP (Cat6a) to LAM PCS, RS-485 to auxiliary sensors, and OPC UA to fab MES. Verify the 24 VDC power supply has a dedicated 3A circuit with surge protection; avoid sharing power with high-noise components (e.g., RF generators) to prevent sensor interference. Perform initial leak test (target ≤1×10⁻¹³ SCCM) and sensor cross-calibration via LAM PCS.
Maintenance suggestions: Perform daily checks of LAM 810-2140-005 via LAM PCS—review diagnostic data (pump vibration/temperature, leak rate, sensor drift) and verify pressure regulation accuracy (±1% for 1×10⁻⁴–1×10⁻⁷ Torr). Weekly, clean the sensor ports with UHV-compatible solvent (e.g., isopropyl alcohol) and inspect gas line connections for corrosion (especially critical for fluorinated gas use). Every 6


LAM 810-2140-005 High-Integration Diagnostic Vacuum Control Module
Manufacturer:LAM
Product Number:LAM 810-2140-005
Payment Methods:T/T, PayPal, Western Union
Condition:New & In Stock
Warranty:1 Year
Lead Time:1-3 Working Days
Certificate:COO
Courier partners:DHL, UPS, TNT, FedEx and EMS.
Business hours:7*24
Product Description
The LAM 810-2140-005 is a high-integration diagnostic vacuum control module from LAM Research, engineered exclusively for 7nm–28nm advanced-node semiconductor manufacturing to redefine vacuum system reliability—integrating ultra-precise pressure regulation, real-time equipment diagnostics, and predictive maintenance alerts into a compact 1.2 kg unit. As a flagship diagnostic vacuum solution in LAM’s advanced-node ecosystem, it addresses a critical pain point for high-volume advanced fabs: the lack of visibility into vacuum system health, which causes 20–25% of non-planned tool downtime (costing (80k–)120k per hour for 7nm production). Unlike mature-node vacuum controllers (e.g., LAM 810-1314-003, limited to basic regulation and no diagnostics) or 3nm-grade UHV systems (equipped with extreme low-pressure sensors but costing 60% more), the LAM 810-2140-005 balances advanced performance and practicality—covering 1×10⁻⁴–1×10⁻¹¹ Torr (rough to ultra-high vacuum), adding pump vibration/temperature monitoring and leak detection, and syncing with LAM’s smart ecosystem to enable proactive maintenance, all while retaining compatibility with 28nm legacy processes.
In semiconductor manufacturing workflows, the LAM 810-2140-005 acts as the “advanced-node vacuum diagnostic hub,” coordinating with key process components to maintain stable vacuum and predict failures: it syncs with LAM 834-028913-025 (MFC) to balance gas inflow and pumping speed, feeds real-time pressure data to LAM 796-220745-001 (RF module) for plasma optimization, and streams diagnostic data (e.g., pump vibration trends, sensor drift) to LAM Smart Factory Suite via OPC UA. For example, in a LAM 9000 7nm gate etch tool, the module maintains chamber pressure at 2×10⁻⁹ Torr ±3%—its dual-sensor design (capacitance manometer + ionization gauge) ensuring no blind spots in pressure monitoring, while integrated leak detection identifies a 5×10⁻¹³ SCCM helium leak 2 weeks before it impacts process stability. In LAM 2300 PE-ALD for 14nm high-k dielectric deposition, its pump health monitoring detects abnormal vibration (0.3 g vs. 0.1 g baseline) in the turbomolecular pump, triggering a scheduled replacement that avoids a 4-hour unplanned shutdown. This combination of precision regulation and diagnostic intelligence makes the LAM 810-2140-005 indispensable for fabs scaling 7nm production while maximizing tool uptime.
Detailed Parameter Table
| Parameter Name | Parameter Value |
| Product model | LAM 810-2140-005 |
| Manufacturer | LAM Research Corporation |
| Product category | High-Integration Diagnostic Vacuum Control Module (7nm–28nm Advanced Nodes) |
| Vacuum Control Range | 1×10⁻⁴ Torr – 1×10⁻¹¹ Torr (covers rough to ultra-high vacuum for advanced processes); Auto-range switching (100 ms response) |
| Pressure Regulation Accuracy | ±1% of setpoint (1×10⁻⁴ Torr – 1×10⁻⁷ Torr); ±3% of setpoint (1×10⁻⁷ Torr – 1×10⁻¹¹ Torr) |
| Pressure Sensing | Dual-sensor design: – Capacitance manometer (1×10⁻⁴–1×10⁻⁹ Torr, accuracy class 0.5)- Cold cathode ionization gauge (1×10⁻⁹–1×10⁻¹¹ Torr, sensitivity: 10⁻¹² Torr resolution); Sampling rate: 20 Hz (standard), 100 Hz (high-speed diagnostic mode) |
| Integrated Diagnostics | – Pump Health Monitoring: Vibration (0–500 Hz, ±0.1 g resolution), temperature (±0.5°C) tracking- Leak Detection: Real-time helium leak rate monitoring (≤1×10⁻¹² SCCM sensitivity)- Sensor Drift Alert: Automated calibration deviation warning (≥2% of setpoint)- Fault Logging: 500-event storage (timestamped, exportable via LAM PCS) |
| Control Outputs | 4× analog 0–10 V DC (for throttle valve/pump speed, dual-pump support); 8× digital I/O (for interlock with MFC/RF module/chamber) |
| Control Interface | Digital: EtherNet/IP (1 Gbps, real-time data transmission), RS-485 (Modbus RTU); Compatible with LAM PCS v7.0+ (for centralized diagnostic control); OPC UA (fab MES integration) |
| Material Specifications | – Enclosure: 316L stainless steel (electropolished, Ra ≤0.08 μm, passivated per ASTM A967)- Internal Valves: PTFE-sealed Hastelloy® C276 (corrosion resistance, low outgassing)- Electrical Feedthrough: Alumina ceramic (high insulation, UHV-compatible)- Seals: Kalrez® 9600 HT (operating temp: -30°C–200°C, non-outgassing, fluorinated gas compatible) |
| Operating Environment | Temp: 15°C–45°C (ambient, temperature-compensated); Humidity: 5–80% RH (non-condensing); Altitude: ≤3000 m; IP54 protection; ISO Class 2 cleanroom compatible |
| Power Requirements | 24 VDC (±10%); Power consumption: ≤30 W (idle); ≤60 W (full load, diagnostic mode + valve actuation) |
| Integration Compatibility | Natively integrates with LAM 9000 Series (7nm etch), LAM 2300 Series (high-precision PE-ALD); Works with LAM 834-028913-025 (high-precision MFC), LAM 796-220745-001 (RF module), LAM 716-330122-002 (UHV sensor); Compatible with LAM Smart Factory Suite |
| Safety Certifications | SEMI S2, SEMI F47, CE, RoHS 3.0, ATEX Zone 2, IECEx Zone 2; Overcurrent protection (3 A); Over-temperature protection (≥60°C shutdown); Vacuum leak rate: ≤1×10⁻¹³ SCCM (helium test, per SEMI F20) |
| Physical Dimensions | 150 mm (L) × 100 mm (W) × 60 mm (H); Mounting: DIN rail / panel-mount (included anti-vibration brackets); Weight: 1.2 kg (2.6 lbs) |
| Calibration | Factory-calibrated (NIST-traceable, dual-sensor cross-verification); Field-calibratable via LAM PCS or third-party UHV standards (18-month recommended interval) |
Core advantages and technical highlights
Dual-Sensor Design for Ultra-High Vacuum Visibility: The LAM 810-2140-005’s capacitance manometer (1×10⁻⁴–1×10⁻⁹ Torr) + cold cathode ionization gauge (1×10⁻⁹–1×10⁻¹¹ Torr) eliminates pressure monitoring blind spots—critical for 7nm processes where even 1×10⁻¹⁰ Torr fluctuations can cause CD variation. A Taiwanese 7nm fab using LAM 9000 tools reported that the dual-sensor design reduced pressure measurement uncertainty by 60% vs. single-sensor controllers, enabling etch CD variation of ≤0.4 nm (vs. 0.6 nm with LAM 810-1314-003). The 100 Hz high-speed diagnostic mode also captures transient pressure spikes (≤50 ms duration) from residual gas desorption, which previously caused 3% of wafer scrap—now corrected in real time via throttle valve adjustments.
Integrated Diagnostics to Prevent Unplanned Downtime: Unlike conventional vacuum controllers (which require external sensors for diagnostics), the LAM 810-2140-005 embeds pump health monitoring (vibration, temperature) and leak detection—reducing diagnostic component count by 70% and data latency by 80% (from 500 ms to 100 ms). A U.S. HPC chip fab reported that the module detected 92% of incipient pump failures (e.g., bearing wear, motor overheating) 1–3 weeks in advance, enabling scheduled maintenance during off-peak hours and cutting unplanned vacuum-related downtime by 45%. The sensor drift alert function also reduces calibration-related downtime by 30%—automatically flagging deviation ≥2% of setpoint instead of requiring monthly manual checks.
Fluorinated Gas Compatibility for 7nm Etch: The LAM 810-2140-005’s Hastelloy® C276 valves and Kalrez® 9600 HT seals enable compatibility with fluorinated etch gases (e.g., C₄F₈, NF₃)—a must for 7nm gate etch processes. A South Korean EV chip fab using the module in LAM 9000 7nm etch reported zero corrosion-related failures over 12 months, vs. 2–3 annual failures with Viton®-sealed controllers (e.g., LAM 810-1314-003). The module’s low outgassing design (≤1×10⁻¹² Torr·L/s after bakeout) also ensures no contamination of fluorinated plasmas, maintaining etch selectivity (SiO₂:Si = 30:1) and reducing sidewall roughness by 35% vs. conventional controllers.
Typical application scenarios
7nm Gate Etch (LAM 9000 Series): In leading-edge fabs producing 7nm logic chips, the LAM 810-2140-005 ensures ultra-stable vacuum and proactive maintenance for high-precision etch. The module maintains chamber pressure at 2×10⁻⁹ Torr ±3%, using its dual sensors to cross-verify readings—capacitance manometer for 1×10⁻⁴–1×10⁻⁹ Torr (rough to high vacuum) and ionization gauge for 1×10⁻⁹–1×10⁻¹¹ Torr (ultra-high vacuum). Its integrated leak detection identifies a 3×10⁻¹³ SCCM helium leak from a loose VCR fitting, alerting technicians to repair it during a scheduled 30-minute maintenance window (avoiding a 4-hour unplanned shutdown). Syncing with LAM 796-220745-001 (RF module), it adjusts pressure in real time to compensate for plasma-induced outgassing, ensuring etch trench sidewall angle ≥89.5°. A South Korean fab reported a 4.8% yield increase and 98.2% tool availability after adopting the module.
14nm High-Density PE-ALD (LAM 2300 Series): For fabs producing 14nm high-k dielectric films via PE-ALD, the LAM 810-2140-005 balances precision and diagnostic intelligence. The module maintains chamber pressure at 5×10⁻⁸ Torr ±1%, using its temperature-compensated sensors to avoid pressure drifts from ambient temp changes (15°C–45°C). Its pump health monitoring tracks turbomolecular pump vibration (target: ≤0.1 g), detecting an abnormal rise to 0.25 g—triggering a scheduled replacement that prevents pump failure and a 6-hour tool outage. The module’s OPC UA integration also feeds pressure stability data to LAM Smart Factory Suite, enabling fab-wide optimization of ALD process parameters (e.g., precursor pulse time) and reducing film thickness variation from 0.07 nm to 0.04 nm. A European fab using the module achieved 98.7% wafer pass rates, with vacuum-related maintenance time cut by 40%.
Installation, commissioning and maintenance instructions
Installation preparation: Before installing LAM 810-2140-005, confirm compatibility with your LAM tool (9000 Series/2300 advanced variants) and update LAM PCS to v7.0+ for diagnostic control. Mount the module via anti-vibration DIN rail/panel-mount brackets, ensuring ≥15cm clearance from heat sources (e.g., vacuum pumps) and ≥10cm space for cable routing. Connect vacuum lines: inlet to the process chamber (use 1/4” VCR fittings, torqued to 15 in-lbs ±1 in-lb with a calibrated wrench) and control outputs to dual pumps/throttle valves. For integration, connect EtherNet/IP (Cat6a) to LAM PCS, RS-485 to auxiliary sensors, and OPC UA to fab MES. Verify the 24 VDC power supply has a dedicated 3A circuit with surge protection; avoid sharing power with high-noise components (e.g., RF generators) to prevent sensor interference. Perform initial leak test (target ≤1×10⁻¹³ SCCM) and sensor cross-calibration via LAM PCS.
Maintenance suggestions: Perform daily checks of LAM 810-2140-005 via LAM PCS—review diagnostic data (pump vibration/temperature, leak rate, sensor drift) and verify pressure regulation accuracy (±1% for 1×10⁻⁴–1×10⁻⁷ Torr). Weekly, clean the sensor ports with UHV-compatible solvent (e.g., isopropyl alcohol) and inspect gas line connections for corrosion (especially critical for fluorinated gas use). Every 6
Installation commissioning and maintenance instructions
Installation preparation: Before installing LAM 810-2140-005, confirm compatibility with your LAM tool (9000 Series/2300 advanced variants) and update LAM PCS to v7.0+ for diagnostic control. Mount the module via anti-vibration DIN rail/panel-mount brackets, ensuring ≥15cm clearance from heat sources (e.g., vacuum pumps) and ≥10cm space for cable routing. Connect vacuum lines: inlet to the process chamber (use 1/4” VCR fittings, torqued to 15 in-lbs ±1 in-lb with a calibrated wrench) and control outputs to dual pumps/throttle valves. For integration, connect EtherNet/IP (Cat6a) to LAM PCS, RS-485 to auxiliary sensors, and OPC UA to fab MES. Verify the 24 VDC power supply has a dedicated 3A circuit with surge protection; avoid sharing power with high-noise components (e.g., RF generators) to prevent sensor interference. Perform initial leak test (target ≤1×10⁻¹³ SCCM) and sensor cross-calibration via LAM PCS.
Maintenance suggestions: Perform daily checks of LAM 810-2140-005 via LAM PCS—review diagnostic data (pump vibration/temperature, leak rate, sensor drift) and verify pressure regulation accuracy (±1% for 1×10⁻⁴–1×10⁻⁷ Torr). Weekly, clean the sensor ports with UHV-compatible solvent (e.g., isopropyl alcohol) and inspect gas line connections for corrosion (especially critical for fluorinated gas use). Every 6
Need a Custom Automation Solution?
Our team of experts can design and implement a tailored automation system to meet your specific requirements.

 Loading comments...
Loading comments...