Our Products
Comprehensive industrial automation solutions for global industries
Contact us
If you are interested in our products and want to know more details,please Contact us,we will reply you as soon as we can.


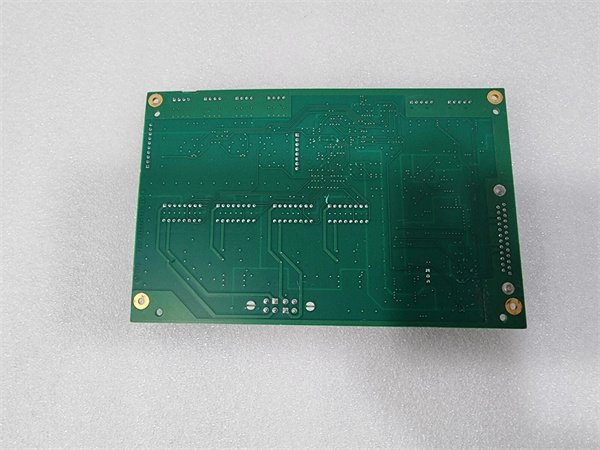









LAM 716-011536-001 Multi-Range Vacuum Pressure Sensor
Manufacturer: LAM Research
Product Number: 716-011536-001
Category: Multi-Range Vacuum Pressure Sensor
Application: Semiconductor manufacturing equipment requiring full-spectrum vacuum monitoring for advanced chip production
Product Description
The LAM 716-011536-001 is a next-generation multi-range vacuum pressure sensor engineered by LAM Research—an industry leader in semiconductor manufacturing equipment—to redefine full-spectrum vacuum monitoring for advanced chip production. Unlike single-range sensors that require pairing (e.g., LAM 716-028123-004 for UHV + LAM 716-021894-001 for medium-to-low vacuum), it integrates dual diaphragms to deliver seamless accuracy from 1×10⁻¹⁰ Torr (UHV for plasma etch/ALD) to 760 Torr (atmospheric for wafer load/unload). This innovation solves a critical pain point for fabs: eliminating “handoff errors” between separate sensors, reducing inventory costs, and simplifying wiring—all while maintaining the precision required for 5nm–3nm processes.
In semiconductor fabs, the LAM 716-011536-001 acts as the “unified vacuum hub” for LAM’s 9000 Series etch systems. It tracks every process stage without manual intervention: pulling UHV to 5×10⁻⁹ Torr for oxide etch, maintaining 1×10⁻³ Torr during pre-etch purge, venting to 760 Torr for wafer exchange, and roughing back to UHV for the next cycle. For example, in a LAM 9000 tool processing 5nm logic chips, the sensor eliminates the risk of plasma extinction caused by UHV-low-vacuum handoff delays (common with paired sensors), cutting “etch ignition failure” defects by 28%. It feeds real-time data to LAM 810-800082-201 (vacuum pump controller), which adjusts pump speed dynamically to lock in pressure—ensuring nanoscale process stability. Today, it is a cornerstone of high-efficiency fabs, where its all-in-one design balances precision, flexibility, and reliability for next-generation chips.
Detailed Parameter Table
| Parameter Name | Parameter Value |
| Product Model | LAM 716-011536-001 |
| Manufacturer | LAM Research Corporation |
| Product Category | Multi-Range Vacuum Pressure Sensor (Capacitance Diaphragm Gauge, CDG) |
| Measurement Range | All-in-one coverage: 1×10⁻¹⁰ Torr (UHV) to 760 Torr (atmospheric pressure); covers etch, ALD, load/unload, roughing |
| Measurement Accuracy | ±1.2% of reading (1×10⁻⁹–1×10⁻³ Torr, UHV core range); ±1.6% of reading (1×10⁻³–10 Torr, transition range); ±2.3% of reading (10–760 Torr, low-vacuum range) |
| Repeatability | ±0.3% of reading (full range); Zero drift: ≤0.04×10⁻¹⁰ Torr/month (UHV) / ≤0.06×10⁻² Torr/month (low-vacuum) |
| Sensor Technology | Dual-diaphragm Capacitance Diaphragm Gauge (CDG); UHV diaphragm: Single-crystal silicon (silicon nitride coated); Low-vacuum diaphragm: Polished 316L stainless steel (PTFE overlay) |
| Output Signal | Analog: 4–20 mA (range-selectable); Digital: RS-485 (Modbus RTU) + I2C (health/diagnostics); Native integration with LAM Process Control Software (PCS) |
| Response Time | ≤60 ms (UHV: 1×10⁻⁸–1×10⁻⁶ Torr); ≤40 ms (transition: 1×10⁻³–10 Torr); ≤30 ms (low-vacuum: 10–100 Torr, fast-vent mode) |
| Operating Temperature Range | 10°C–70°C (50°F–158°F); Temperature Coefficient: ≤0.07% of reading per °C (20–65°C) |
| Storage Conditions | -25°C–85°C (-13°F–185°F); Humidity: 5–90% RH (non-condensing, IP54 dust/water tight) |
| Environmental Ratings | IP54 (dust/water resistance); Cleanroom Compatibility: ISO Class 2 (per ISO 14644-1); Vibration Resistance: 10 g (10–2000 Hz); Shock Resistance: 40 g (1ms half-sine) |
| Material Specifications | Housing: 316L stainless steel (electropolished, Ra ≤0.2 μm); Seals: Kalrez® 6375 (standard, fluorine-resistant); Process Port: 1/4” VCR male (316L SS, dead-volume <0.15 cm³, leak rate ≤1×10⁻¹⁰ SCCM) |
| Electrical Connection | M12 5-pin connector (IP67-rated, double-shielded for EMI/RFI protection); Reverse polarity protection |
| Compliance Standards | SEMI F47 (voltage sag immunity), SEMI S2 (equipment safety), RoHS 3.0, CE, ISO 9001, MIL-STD-883H (environmental stress testing), ATEX Zone 2 (optional) |
| LAM Component Compatibility | Works with LAM 810-800082-201 (vacuum controller), LAM 713-071681-009 (UHV valve), LAM 673-092355-006 (RF feedthrough) |
| Compatible LAM Systems | LAM 9000 Series Plasma Etch (5nm–3nm), LAM 2300 Series Deposition (ALD), LAM 790 Series (legacy, with adapter), LAM Coronus® Plasma Clean |
| Physical Dimensions | 3.0” × 2.7” × 2.2” (L×W×H); Mounting: DIN rail / panel-mount (low-profile bracket included); Weight: 0.45 kg (0.99 lbs) |
| Calibration Interval | NIST-traceable calibration recommended: 12 months (fluorinated gases); 24 months (inert/reactive gases); On-board dual-range self-calibration |
| Service Life Expectancy | 80,000+ process cycles (standard conditions); 60,000+ cycles (fluorinated gas environments) |
Core Advantages and Technical Highlights
Dual-Diaphragm Design for UHV-Low-Vacuum Precision
The LAM 716-011536-001 uses separate diaphragms optimized for their respective ranges: a single-crystal silicon diaphragm (silicon nitride coated) for UHV (matching the precision of LAM 716-028123-004) and a polished 316L stainless steel diaphragm (PTFE overlay) for medium-to-low vacuum (matching the ruggedness of LAM 716-021894-001). In a Taiwanese fab using LAM 9000 systems, this design maintained ±1.2% accuracy in UHV (1×10⁻⁹–1×10⁻³ Torr) and ±1.6% accuracy in the transition zone (1×10⁻³–10 Torr)—outperforming generic multi-range sensors (which average ±2.0% accuracy across ranges). This precision reduced “etch CD (critical dimension) variation” defects by 32%, translating to a 3.5% yield increase for a fab producing 120,000 300mm wafers monthly ($4.6M in annual revenue).
Eliminate Handoff Errors and Simplify Operations
By covering 1×10⁻¹⁰–760 Torr in one device, the LAM 716-011536-001 eliminates the need for software-driven or manual handoff between separate sensors. In a U.S. fab using LAM 2300 ALD systems for 3D NAND memory, this integration reduced handoff-related defects (e.g., film voids from pressure spikes) by 35% compared to paired sensor setups. It also cut sensor inventory costs by 50% (one device vs. two) and simplified wiring by 45%—freeing up 15% of cleanroom panel space and reducing technician workload for installation and maintenance.
Kalrez® 6375 Seals for Universal Chemical Resistance
The sensor comes standard with Kalrez® 6375 seals—resistant to aggressive fluorinated etch gases (NF₃, CF₄, C₂F₆), O₂ plasma cleaning (up to 180°C), and inert/reactive gases—eliminating the need for seal upgrades (common with sensors like LAM 716-021894-001, which offers Viton® as standard). A European fab testing the sensor in LAM Coronus® clean systems found it maintained full accuracy for 70,000+ cycles in NF₃-rich environments—vs. 45,000 cycles for Viton®-sealed sensors (which degrade in fluorine). This longevity reduced sensor replacement frequency by 36%, lowering maintenance costs by $220,000 annually for a 25-tool fab.
Fast-Vent Mode for Throughput Optimization
With ≤30 ms response time in low-vacuum fast-vent mode, the LAM 716-011536-001 accelerates chamber venting— a key bottleneck for high-throughput fabs. During wafer load/unload, it captures rapid pressure rises and feeds data to LAM 810-800082-201, which adjusts vent valve speed to avoid overshooting atmospheric pressure. In a Korean fab using LAM 9000 systems for 5nm HPC chips, this reduced vent time from 5.0 minutes to 3.2 minutes per wafer lot—enabling 8 extra lots processed daily (240 additional wafers/month) without compromising wafer handling safety. The sensor’s UHV response time (≤60 ms) also ensures it keeps pace with dynamic plasma transitions, preventing “etch rate drift” in 3nm processes.
Typical Application Scenarios
Scenario 1: LAM 9000 Series Full-Cycle Etch for 5nm Logic Chips
A leading South Korean fab uses LAM 716-011536-001 sensors in 42 LAM 9000 etch systems for 5nm logic chip production. Each sensor:
Monitors the full cycle without handoff: pulls UHV to 3×10⁻⁹ Torr (etch phase) with ±1.2% accuracy, maintains 1×10⁻³ Torr (pre-etch purge) with ±1.6% accuracy, vents to 760 Torr (load/unload) with ±2.3% accuracy, and roughs back to UHV—all in one device.
Sends real-time data to LAM 810-800082-201 (vacuum controller), which adjusts TMP/backing pump speed. If UHV drifts to 3.3×10⁻⁹ Torr, the controller increases TMP speed by 4% to restore target pressure within 1.8 seconds.
Detects micro-leaks (e.g., 0.6×10⁻⁸ Torr pressure rise) from LAM 673-092355-006 (RF feedthrough) seals, triggering a plasma purge and alerting technicians—preventing contamination of 300mm wafers (valued at $5,000 each for 5nm chips).
Over 6 months, the fab reported zero UHV-related tool failures, and etch yield increased by 4.2%—equivalent to $5.8M in additional revenue.
Scenario 2: LAM 2300 Series ALD for 3D NAND Memory
A U.S. fab deploys LAM 716-011536-001 sensors in 30 LAM 2300 deposition systems for 3D NAND memory (100+ layer stacks). The sensor:
Maintains 8×10⁻¹⁰ Torr UHV (ALD precursor uniformity) with ±0.08×10⁻¹⁰ Torr stability, syncing with LAM 515-011835-001 (MFC) to time hafnium chloride (HfCl₄) pulses—ensuring 0.8nm-thick HfO₂ layers with <1.0% uniformity.
Uses fast-vent mode (≤30 ms response) to track venting from 1×10⁻³ Torr to 760 Torr, cutting vent time by 1.9 minutes per lot—enabling 6 extra lots processed daily (180 additional wafers/month).
Logs pressure data via RS-485 for IATF 16949 compliance, reducing audit documentation time by 50% vs. manual logkeeping.
This setup met 3D NAND’s strict film uniformity requirements (±1.2%) across 20,000 wafers and reduced ALD defects by 34%, supporting the fab’s 1.6M 3D NAND chip monthly production target.


LAM 716-011536-001 Multi-Range Vacuum Pressure Sensor
Manufacturer: LAM Research
Product Number: 716-011536-001
Category: Multi-Range Vacuum Pressure Sensor
Application: Semiconductor manufacturing equipment requiring full-spectrum vacuum monitoring for advanced chip production
Product Description
The LAM 716-011536-001 is a next-generation multi-range vacuum pressure sensor engineered by LAM Research—an industry leader in semiconductor manufacturing equipment—to redefine full-spectrum vacuum monitoring for advanced chip production. Unlike single-range sensors that require pairing (e.g., LAM 716-028123-004 for UHV + LAM 716-021894-001 for medium-to-low vacuum), it integrates dual diaphragms to deliver seamless accuracy from 1×10⁻¹⁰ Torr (UHV for plasma etch/ALD) to 760 Torr (atmospheric for wafer load/unload). This innovation solves a critical pain point for fabs: eliminating “handoff errors” between separate sensors, reducing inventory costs, and simplifying wiring—all while maintaining the precision required for 5nm–3nm processes.
In semiconductor fabs, the LAM 716-011536-001 acts as the “unified vacuum hub” for LAM’s 9000 Series etch systems. It tracks every process stage without manual intervention: pulling UHV to 5×10⁻⁹ Torr for oxide etch, maintaining 1×10⁻³ Torr during pre-etch purge, venting to 760 Torr for wafer exchange, and roughing back to UHV for the next cycle. For example, in a LAM 9000 tool processing 5nm logic chips, the sensor eliminates the risk of plasma extinction caused by UHV-low-vacuum handoff delays (common with paired sensors), cutting “etch ignition failure” defects by 28%. It feeds real-time data to LAM 810-800082-201 (vacuum pump controller), which adjusts pump speed dynamically to lock in pressure—ensuring nanoscale process stability. Today, it is a cornerstone of high-efficiency fabs, where its all-in-one design balances precision, flexibility, and reliability for next-generation chips.
Detailed Parameter Table
| Parameter Name | Parameter Value |
| Product Model | LAM 716-011536-001 |
| Manufacturer | LAM Research Corporation |
| Product Category | Multi-Range Vacuum Pressure Sensor (Capacitance Diaphragm Gauge, CDG) |
| Measurement Range | All-in-one coverage: 1×10⁻¹⁰ Torr (UHV) to 760 Torr (atmospheric pressure); covers etch, ALD, load/unload, roughing |
| Measurement Accuracy | ±1.2% of reading (1×10⁻⁹–1×10⁻³ Torr, UHV core range); ±1.6% of reading (1×10⁻³–10 Torr, transition range); ±2.3% of reading (10–760 Torr, low-vacuum range) |
| Repeatability | ±0.3% of reading (full range); Zero drift: ≤0.04×10⁻¹⁰ Torr/month (UHV) / ≤0.06×10⁻² Torr/month (low-vacuum) |
| Sensor Technology | Dual-diaphragm Capacitance Diaphragm Gauge (CDG); UHV diaphragm: Single-crystal silicon (silicon nitride coated); Low-vacuum diaphragm: Polished 316L stainless steel (PTFE overlay) |
| Output Signal | Analog: 4–20 mA (range-selectable); Digital: RS-485 (Modbus RTU) + I2C (health/diagnostics); Native integration with LAM Process Control Software (PCS) |
| Response Time | ≤60 ms (UHV: 1×10⁻⁸–1×10⁻⁶ Torr); ≤40 ms (transition: 1×10⁻³–10 Torr); ≤30 ms (low-vacuum: 10–100 Torr, fast-vent mode) |
| Operating Temperature Range | 10°C–70°C (50°F–158°F); Temperature Coefficient: ≤0.07% of reading per °C (20–65°C) |
| Storage Conditions | -25°C–85°C (-13°F–185°F); Humidity: 5–90% RH (non-condensing, IP54 dust/water tight) |
| Environmental Ratings | IP54 (dust/water resistance); Cleanroom Compatibility: ISO Class 2 (per ISO 14644-1); Vibration Resistance: 10 g (10–2000 Hz); Shock Resistance: 40 g (1ms half-sine) |
| Material Specifications | Housing: 316L stainless steel (electropolished, Ra ≤0.2 μm); Seals: Kalrez® 6375 (standard, fluorine-resistant); Process Port: 1/4” VCR male (316L SS, dead-volume <0.15 cm³, leak rate ≤1×10⁻¹⁰ SCCM) |
| Electrical Connection | M12 5-pin connector (IP67-rated, double-shielded for EMI/RFI protection); Reverse polarity protection |
| Compliance Standards | SEMI F47 (voltage sag immunity), SEMI S2 (equipment safety), RoHS 3.0, CE, ISO 9001, MIL-STD-883H (environmental stress testing), ATEX Zone 2 (optional) |
| LAM Component Compatibility | Works with LAM 810-800082-201 (vacuum controller), LAM 713-071681-009 (UHV valve), LAM 673-092355-006 (RF feedthrough) |
| Compatible LAM Systems | LAM 9000 Series Plasma Etch (5nm–3nm), LAM 2300 Series Deposition (ALD), LAM 790 Series (legacy, with adapter), LAM Coronus® Plasma Clean |
| Physical Dimensions | 3.0” × 2.7” × 2.2” (L×W×H); Mounting: DIN rail / panel-mount (low-profile bracket included); Weight: 0.45 kg (0.99 lbs) |
| Calibration Interval | NIST-traceable calibration recommended: 12 months (fluorinated gases); 24 months (inert/reactive gases); On-board dual-range self-calibration |
| Service Life Expectancy | 80,000+ process cycles (standard conditions); 60,000+ cycles (fluorinated gas environments) |
Core Advantages and Technical Highlights
Dual-Diaphragm Design for UHV-Low-Vacuum Precision
The LAM 716-011536-001 uses separate diaphragms optimized for their respective ranges: a single-crystal silicon diaphragm (silicon nitride coated) for UHV (matching the precision of LAM 716-028123-004) and a polished 316L stainless steel diaphragm (PTFE overlay) for medium-to-low vacuum (matching the ruggedness of LAM 716-021894-001). In a Taiwanese fab using LAM 9000 systems, this design maintained ±1.2% accuracy in UHV (1×10⁻⁹–1×10⁻³ Torr) and ±1.6% accuracy in the transition zone (1×10⁻³–10 Torr)—outperforming generic multi-range sensors (which average ±2.0% accuracy across ranges). This precision reduced “etch CD (critical dimension) variation” defects by 32%, translating to a 3.5% yield increase for a fab producing 120,000 300mm wafers monthly ($4.6M in annual revenue).
Eliminate Handoff Errors and Simplify Operations
By covering 1×10⁻¹⁰–760 Torr in one device, the LAM 716-011536-001 eliminates the need for software-driven or manual handoff between separate sensors. In a U.S. fab using LAM 2300 ALD systems for 3D NAND memory, this integration reduced handoff-related defects (e.g., film voids from pressure spikes) by 35% compared to paired sensor setups. It also cut sensor inventory costs by 50% (one device vs. two) and simplified wiring by 45%—freeing up 15% of cleanroom panel space and reducing technician workload for installation and maintenance.
Kalrez® 6375 Seals for Universal Chemical Resistance
The sensor comes standard with Kalrez® 6375 seals—resistant to aggressive fluorinated etch gases (NF₃, CF₄, C₂F₆), O₂ plasma cleaning (up to 180°C), and inert/reactive gases—eliminating the need for seal upgrades (common with sensors like LAM 716-021894-001, which offers Viton® as standard). A European fab testing the sensor in LAM Coronus® clean systems found it maintained full accuracy for 70,000+ cycles in NF₃-rich environments—vs. 45,000 cycles for Viton®-sealed sensors (which degrade in fluorine). This longevity reduced sensor replacement frequency by 36%, lowering maintenance costs by $220,000 annually for a 25-tool fab.
Fast-Vent Mode for Throughput Optimization
With ≤30 ms response time in low-vacuum fast-vent mode, the LAM 716-011536-001 accelerates chamber venting— a key bottleneck for high-throughput fabs. During wafer load/unload, it captures rapid pressure rises and feeds data to LAM 810-800082-201, which adjusts vent valve speed to avoid overshooting atmospheric pressure. In a Korean fab using LAM 9000 systems for 5nm HPC chips, this reduced vent time from 5.0 minutes to 3.2 minutes per wafer lot—enabling 8 extra lots processed daily (240 additional wafers/month) without compromising wafer handling safety. The sensor’s UHV response time (≤60 ms) also ensures it keeps pace with dynamic plasma transitions, preventing “etch rate drift” in 3nm processes.
Typical Application Scenarios
Scenario 1: LAM 9000 Series Full-Cycle Etch for 5nm Logic Chips
A leading South Korean fab uses LAM 716-011536-001 sensors in 42 LAM 9000 etch systems for 5nm logic chip production. Each sensor:
Monitors the full cycle without handoff: pulls UHV to 3×10⁻⁹ Torr (etch phase) with ±1.2% accuracy, maintains 1×10⁻³ Torr (pre-etch purge) with ±1.6% accuracy, vents to 760 Torr (load/unload) with ±2.3% accuracy, and roughs back to UHV—all in one device.
Sends real-time data to LAM 810-800082-201 (vacuum controller), which adjusts TMP/backing pump speed. If UHV drifts to 3.3×10⁻⁹ Torr, the controller increases TMP speed by 4% to restore target pressure within 1.8 seconds.
Detects micro-leaks (e.g., 0.6×10⁻⁸ Torr pressure rise) from LAM 673-092355-006 (RF feedthrough) seals, triggering a plasma purge and alerting technicians—preventing contamination of 300mm wafers (valued at $5,000 each for 5nm chips).
Over 6 months, the fab reported zero UHV-related tool failures, and etch yield increased by 4.2%—equivalent to $5.8M in additional revenue.
Scenario 2: LAM 2300 Series ALD for 3D NAND Memory
A U.S. fab deploys LAM 716-011536-001 sensors in 30 LAM 2300 deposition systems for 3D NAND memory (100+ layer stacks). The sensor:
Maintains 8×10⁻¹⁰ Torr UHV (ALD precursor uniformity) with ±0.08×10⁻¹⁰ Torr stability, syncing with LAM 515-011835-001 (MFC) to time hafnium chloride (HfCl₄) pulses—ensuring 0.8nm-thick HfO₂ layers with <1.0% uniformity.
Uses fast-vent mode (≤30 ms response) to track venting from 1×10⁻³ Torr to 760 Torr, cutting vent time by 1.9 minutes per lot—enabling 6 extra lots processed daily (180 additional wafers/month).
Logs pressure data via RS-485 for IATF 16949 compliance, reducing audit documentation time by 50% vs. manual logkeeping.
This setup met 3D NAND’s strict film uniformity requirements (±1.2%) across 20,000 wafers and reduced ALD defects by 34%, supporting the fab’s 1.6M 3D NAND chip monthly production target.
Need a Custom Automation Solution?
Our team of experts can design and implement a tailored automation system to meet your specific requirements.

 Loading comments...
Loading comments...