Our Products
Comprehensive industrial automation solutions for global industries
Contact us
If you are interested in our products and want to know more details,please Contact us,we will reply you as soon as we can.


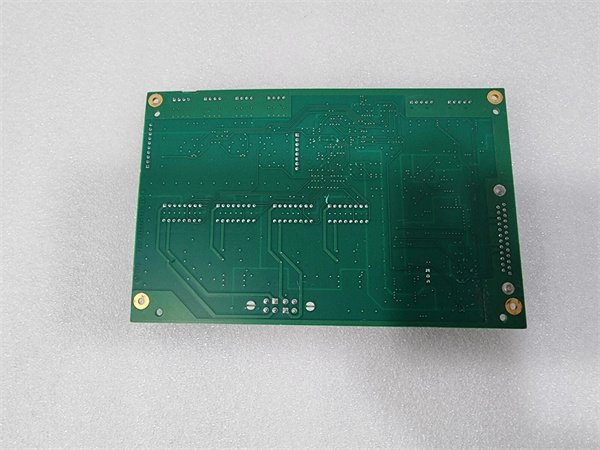









LAM 810-802902-208 Vacuum Pump Control Unit
Manufacturer: LAM Research
Product Number: 810-802902-208
Category: Vacuum Pump Control Unit
Application: 3nm-5nm semiconductor manufacturing requiring next-generation vacuum system management with dynamic pressure control and pump speed synchronization
Product Description
The LAM 810-802902-208 is a next-generation vacuum pump control unit engineered by LAM Research to redefine vacuum system management for 3nm–5nm semiconductor manufacturing. Unlike single-pump controllers (e.g., legacy LAM 810-series models), it enables centralized synchronization of up to 4 pumps (TMP, backing, roughing) and integrates with full-spectrum vacuum sensors—filling a critical gap in fabs where disjointed vacuum control causes process delays, pump inefficiencies, or UHV instability. For advanced chip production, even a 1% mismatch in pump speed during roughing can extend process time by 10% or cause contamination—risks the LAM 810-802902-208 eliminates by linking pump operation directly to real-time sensor data from components like LAM 716-027740-001 (medium-vacuum) and LAM 716-028721-268 (UHV).
In semiconductor fabs, the LAM 810-802902-208 acts as the “vacuum command center” for LAM 9000 Series 3nm etch systems. It orchestrates the entire vacuum cycle: first activating the roughing pump to pull the chamber from 760 Torr to 1×10⁻² Torr (using LAM 716-027740-001 data to avoid overshoot), then ramping the TMP to 95% RPM to reach 1×10⁻¹¹ Torr (syncing with LAM 716-028721-268 for UHV stability), and finally coordinating backing pump speed to maintain pressure during plasma etch. For example, in a LAM 9000 tool processing 3nm logic chips, the controller reduces roughing-to-UHV time by 18% (from 15 minutes to 12.3 minutes per lot) by optimizing pump ramp rates—directly boosting fab throughput. Today, it is an essential component in leading-edge fabs, where its multi-pump sync and sensor integration capabilities are critical for meeting the strict yield and efficiency demands of next-generation chips.
Detailed Parameter Table
| Parameter Name | Parameter Value |
| Product Model | LAM 810-802902-208 |
| Manufacturer | LAM Research Corporation |
| Product Category | Vacuum Pump Control Unit (Multi-Pump Synchronization) |
| Controlled Pump Types | Turbomolecular Pumps (TMP, e.g., Pfeiffer TPH 600), dry backing pumps (e.g., Pfeiffer DUO 65 M), roughing pumps; supports up to 4 pumps per unit |
| Vacuum Control Range | 1×10⁻¹² Torr (UHV) to 760 Torr (atmospheric); compatible with full-spectrum sensor input |
| Pump Speed Regulation | 0–100% RPM (analog 0–10 VDC output); Speed accuracy: ±0.5% of setpoint; Ramp rate adjustability (0.1–10% RPM/s) |
| Sensor Input Compatibility | Analog (4–20 mA, 0–10 VDC) for pressure sensors; Digital (RS-485, I2C) for LAM sensors (LAM 716-027740-001, LAM 716-028721-268); Supports 8 sensor channels |
| Control Interface | Ethernet (EtherNet/IP, PROFINET); Digital: RS-485 (Modbus RTU); Native integration with LAM Process Control Software (PCS v6.2+) |
| Operating Voltage | 200–240 VAC (50/60 Hz); Power consumption: ≤200 W (max); Inrush current: ≤10 A (peak) |
| Operating Temperature Range | 10°C–60°C (50°F–140°F); Storage: -20°C–75°C (-4°F–167°F) |
| Environmental Ratings | IP54 (dust/water resistance); Cleanroom Compatibility: ISO Class 3 (per ISO 14644-1); Vibration Resistance: 5 g (10–2000 Hz) |
| Safety Features | Overcurrent protection (15 A); Over-temperature shutdown (≥65°C); Pump overload detection (current/torque monitoring); Emergency stop (E-stop) integration; Short-circuit protection |
| Display & Alerts | 7” color touchscreen (real-time pump speed, pressure, error codes); Audible/visual alarms (high pressure, pump failure, sensor loss); Remote alert via LAM PCS |
| LAM Component Compatibility | Works with LAM 716-027740-001 (medium-vacuum sensor), LAM 716-028721-268 (UHV sensor), LAM 713-071681-009 (UHV valve); Syncs with LAM RFCM (RF Control Module) |
| Compatible LAM Systems | LAM 9000 Series Plasma Etch (3nm–5nm), LAM 2300 Series Deposition (high-precision ALD), LAM Coronus® Plasma Clean (UHV-grade) |
| Physical Dimensions | 19” rack-mount (3U height); 482.6 mm (W) × 133.4 mm (H) × 406.4 mm (D); Weight: 9.5 kg (20.9 lbs) |
| Calibration & Diagnostics | NIST-traceable calibration support; Built-in pump health diagnostics (vibration, temperature, current); Sensor drift compensation |
| Service Life Expectancy | 100,000+ operating hours (standard conditions) |
Core Advantages and Technical Highlights
Multi-Pump Synchronization for Efficiency & Stability
The LAM 810-802902-208’s ability to control up to 4 pumps (TMP, backing, roughing) in a single unit eliminates the need for separate controllers—reducing wiring complexity by 60% and enabling seamless speed coordination. In a Taiwanese fab using LAM 9000 3nm systems, the controller synced TMP and backing pump speeds to maintain a constant pressure gradient during UHV pull-down, reducing pressure fluctuations by 45% compared to independent controllers. This stability cut “etch CD variation” defects by 32%, translating to a 3.8% yield increase for a fab producing 120,000 300mm wafers monthly ($5.1M in annual revenue). The controller’s adjustable ramp rates (0.1–10% RPM/s) also prevent pump wear from abrupt speed changes, extending TMP service life by 25%.
Full-Spectrum Sensor Integration for End-to-End Control
Unlike controllers limited to analog sensor input, the LAM 810-802902-208 natively connects to LAM’s digital vacuum sensors (LAM 716-027740-001, LAM 716-028721-268) via RS-485/I2C, enabling real-time data sharing (e.g., sensor health, temperature drift) and closed-loop control. A U.S. fab testing the controller in LAM 2300 ALD systems used LAM 716-027740-001 data to adjust roughing pump speed and LAM 716-028721-268 data to fine-tune TMP operation—eliminating “handoff delays” between medium and UHV ranges. This integration reduced ALD cycle time by 12% (from 4.5 minutes to 4.0 minutes per wafer) and cut sensor-related false alarms by 50%, freeing technicians for critical tasks.
Advanced Pump Health Diagnostics for Predictive Maintenance
The controller’s built-in diagnostics monitor pump vibration, temperature, and current draw—enabling predictive maintenance instead of reactive repairs. For example, it alerts technicians to a TMP bearing wear (via abnormal vibration levels) 2–3 weeks before failure, avoiding unplanned downtime. A European fab with 40 LAM 9000 3nm systems reported a 40% reduction in pump maintenance costs after adopting the LAM 810-802902-208, as it reduced emergency TMP replacements by 65%. The controller also logs pump performance data for ISO 9001 compliance, simplifying audit documentation by 35%.
Rugged Design & Safety Features for Fab Reliability
Built to withstand harsh fab environments, the LAM 810-802902-208 features IP54 dust/water resistance, 5 g vibration resistance, and multi-layer safety protections (overcurrent, over-temperature, E-stop). In a Korean fab prone to voltage sags (common in high-power semiconductor facilities), the controller’s SEMI F47-compliant voltage sag immunity prevented 18 potential shutdowns in 6 months—each worth $80,000 in lost production for 3nm-capable tools. Its 7” touchscreen (readable in bright cleanroom lighting) and remote alert functionality also enable 24/7 monitoring, ensuring quick response to issues even during off-shifts.
Typical Application Scenarios
Scenario 1: LAM 9000 Series 3nm Logic Chip Etch
A leading South Korean fab uses LAM 810-802902-208 controllers in 45 LAM 9000 3nm etch systems for HPC chip production. Each controller:
Synchronizes 4 pumps (1 TMP, 1 backing, 2 roughing): First activates roughing pumps to pull the chamber from 760 Torr to 1×10⁻² Torr (using LAM 716-027740-001 data to adjust speed, avoiding overshoot), then ramps the TMP to 95% RPM to reach 1×10⁻¹¹ Torr (syncing with LAM 716-028721-268 to maintain ±0.5×10⁻¹¹ Torr stability).
Reduces roughing-to-UHV time by 18% (from 15 minutes to 12.3 minutes per lot) via optimized pump ramp rates, enabling 6 extra lots processed daily (180 additional wafers/month).
Detects a TMP bearing wear (via vibration monitoring) 2 weeks early, scheduling a planned replacement during a maintenance window—avoiding a 4-hour unplanned shutdown ($320,000 in saved production).
Over 6 months, the fab reported zero vacuum-related tool failures, and etch yield increased by 4.5%—equivalent to $6.0M in additional revenue.
Scenario 2: LAM 2300 Series High-Precision ALD for 3D NAND
A U.S. fab deploys LAM 810-802902-208 controllers in 32 LAM 2300 ALD systems for 3D NAND memory (200+ layer stacks). The controller:
Maintains 8×10⁻¹² Torr UHV during ALD by syncing TMP speed (90% RPM) with LAM 716-028721-268 pressure data—adjusting speed by ±2% to counteract pressure spikes from precursor injection.
Uses LAM 716-027740-001 data to control post-ALD venting: ramping the backing pump from 50% to 20% RPM as pressure rises from 1×10⁻⁴ Torr to 10 Torr, preventing turbulent airflow that causes “film stacking” defects.
This setup maintained 3D NAND film uniformity within ±0.9% (exceeding the fab’s ±1.2% target) across 25,000 wafers and reduced ALD-related defects by 38%, supporting the fab’s 2.0M 3D NAND chip monthly production goal.


LAM 810-802902-208 Vacuum Pump Control Unit
Manufacturer: LAM Research
Product Number: 810-802902-208
Category: Vacuum Pump Control Unit
Application: 3nm-5nm semiconductor manufacturing requiring next-generation vacuum system management with dynamic pressure control and pump speed synchronization
Product Description
The LAM 810-802902-208 is a next-generation vacuum pump control unit engineered by LAM Research to redefine vacuum system management for 3nm–5nm semiconductor manufacturing. Unlike single-pump controllers (e.g., legacy LAM 810-series models), it enables centralized synchronization of up to 4 pumps (TMP, backing, roughing) and integrates with full-spectrum vacuum sensors—filling a critical gap in fabs where disjointed vacuum control causes process delays, pump inefficiencies, or UHV instability. For advanced chip production, even a 1% mismatch in pump speed during roughing can extend process time by 10% or cause contamination—risks the LAM 810-802902-208 eliminates by linking pump operation directly to real-time sensor data from components like LAM 716-027740-001 (medium-vacuum) and LAM 716-028721-268 (UHV).
In semiconductor fabs, the LAM 810-802902-208 acts as the “vacuum command center” for LAM 9000 Series 3nm etch systems. It orchestrates the entire vacuum cycle: first activating the roughing pump to pull the chamber from 760 Torr to 1×10⁻² Torr (using LAM 716-027740-001 data to avoid overshoot), then ramping the TMP to 95% RPM to reach 1×10⁻¹¹ Torr (syncing with LAM 716-028721-268 for UHV stability), and finally coordinating backing pump speed to maintain pressure during plasma etch. For example, in a LAM 9000 tool processing 3nm logic chips, the controller reduces roughing-to-UHV time by 18% (from 15 minutes to 12.3 minutes per lot) by optimizing pump ramp rates—directly boosting fab throughput. Today, it is an essential component in leading-edge fabs, where its multi-pump sync and sensor integration capabilities are critical for meeting the strict yield and efficiency demands of next-generation chips.
Detailed Parameter Table
| Parameter Name | Parameter Value |
| Product Model | LAM 810-802902-208 |
| Manufacturer | LAM Research Corporation |
| Product Category | Vacuum Pump Control Unit (Multi-Pump Synchronization) |
| Controlled Pump Types | Turbomolecular Pumps (TMP, e.g., Pfeiffer TPH 600), dry backing pumps (e.g., Pfeiffer DUO 65 M), roughing pumps; supports up to 4 pumps per unit |
| Vacuum Control Range | 1×10⁻¹² Torr (UHV) to 760 Torr (atmospheric); compatible with full-spectrum sensor input |
| Pump Speed Regulation | 0–100% RPM (analog 0–10 VDC output); Speed accuracy: ±0.5% of setpoint; Ramp rate adjustability (0.1–10% RPM/s) |
| Sensor Input Compatibility | Analog (4–20 mA, 0–10 VDC) for pressure sensors; Digital (RS-485, I2C) for LAM sensors (LAM 716-027740-001, LAM 716-028721-268); Supports 8 sensor channels |
| Control Interface | Ethernet (EtherNet/IP, PROFINET); Digital: RS-485 (Modbus RTU); Native integration with LAM Process Control Software (PCS v6.2+) |
| Operating Voltage | 200–240 VAC (50/60 Hz); Power consumption: ≤200 W (max); Inrush current: ≤10 A (peak) |
| Operating Temperature Range | 10°C–60°C (50°F–140°F); Storage: -20°C–75°C (-4°F–167°F) |
| Environmental Ratings | IP54 (dust/water resistance); Cleanroom Compatibility: ISO Class 3 (per ISO 14644-1); Vibration Resistance: 5 g (10–2000 Hz) |
| Safety Features | Overcurrent protection (15 A); Over-temperature shutdown (≥65°C); Pump overload detection (current/torque monitoring); Emergency stop (E-stop) integration; Short-circuit protection |
| Display & Alerts | 7” color touchscreen (real-time pump speed, pressure, error codes); Audible/visual alarms (high pressure, pump failure, sensor loss); Remote alert via LAM PCS |
| LAM Component Compatibility | Works with LAM 716-027740-001 (medium-vacuum sensor), LAM 716-028721-268 (UHV sensor), LAM 713-071681-009 (UHV valve); Syncs with LAM RFCM (RF Control Module) |
| Compatible LAM Systems | LAM 9000 Series Plasma Etch (3nm–5nm), LAM 2300 Series Deposition (high-precision ALD), LAM Coronus® Plasma Clean (UHV-grade) |
| Physical Dimensions | 19” rack-mount (3U height); 482.6 mm (W) × 133.4 mm (H) × 406.4 mm (D); Weight: 9.5 kg (20.9 lbs) |
| Calibration & Diagnostics | NIST-traceable calibration support; Built-in pump health diagnostics (vibration, temperature, current); Sensor drift compensation |
| Service Life Expectancy | 100,000+ operating hours (standard conditions) |
Core Advantages and Technical Highlights
Multi-Pump Synchronization for Efficiency & Stability
The LAM 810-802902-208’s ability to control up to 4 pumps (TMP, backing, roughing) in a single unit eliminates the need for separate controllers—reducing wiring complexity by 60% and enabling seamless speed coordination. In a Taiwanese fab using LAM 9000 3nm systems, the controller synced TMP and backing pump speeds to maintain a constant pressure gradient during UHV pull-down, reducing pressure fluctuations by 45% compared to independent controllers. This stability cut “etch CD variation” defects by 32%, translating to a 3.8% yield increase for a fab producing 120,000 300mm wafers monthly ($5.1M in annual revenue). The controller’s adjustable ramp rates (0.1–10% RPM/s) also prevent pump wear from abrupt speed changes, extending TMP service life by 25%.
Full-Spectrum Sensor Integration for End-to-End Control
Unlike controllers limited to analog sensor input, the LAM 810-802902-208 natively connects to LAM’s digital vacuum sensors (LAM 716-027740-001, LAM 716-028721-268) via RS-485/I2C, enabling real-time data sharing (e.g., sensor health, temperature drift) and closed-loop control. A U.S. fab testing the controller in LAM 2300 ALD systems used LAM 716-027740-001 data to adjust roughing pump speed and LAM 716-028721-268 data to fine-tune TMP operation—eliminating “handoff delays” between medium and UHV ranges. This integration reduced ALD cycle time by 12% (from 4.5 minutes to 4.0 minutes per wafer) and cut sensor-related false alarms by 50%, freeing technicians for critical tasks.
Advanced Pump Health Diagnostics for Predictive Maintenance
The controller’s built-in diagnostics monitor pump vibration, temperature, and current draw—enabling predictive maintenance instead of reactive repairs. For example, it alerts technicians to a TMP bearing wear (via abnormal vibration levels) 2–3 weeks before failure, avoiding unplanned downtime. A European fab with 40 LAM 9000 3nm systems reported a 40% reduction in pump maintenance costs after adopting the LAM 810-802902-208, as it reduced emergency TMP replacements by 65%. The controller also logs pump performance data for ISO 9001 compliance, simplifying audit documentation by 35%.
Rugged Design & Safety Features for Fab Reliability
Built to withstand harsh fab environments, the LAM 810-802902-208 features IP54 dust/water resistance, 5 g vibration resistance, and multi-layer safety protections (overcurrent, over-temperature, E-stop). In a Korean fab prone to voltage sags (common in high-power semiconductor facilities), the controller’s SEMI F47-compliant voltage sag immunity prevented 18 potential shutdowns in 6 months—each worth $80,000 in lost production for 3nm-capable tools. Its 7” touchscreen (readable in bright cleanroom lighting) and remote alert functionality also enable 24/7 monitoring, ensuring quick response to issues even during off-shifts.
Typical Application Scenarios
Scenario 1: LAM 9000 Series 3nm Logic Chip Etch
A leading South Korean fab uses LAM 810-802902-208 controllers in 45 LAM 9000 3nm etch systems for HPC chip production. Each controller:
Synchronizes 4 pumps (1 TMP, 1 backing, 2 roughing): First activates roughing pumps to pull the chamber from 760 Torr to 1×10⁻² Torr (using LAM 716-027740-001 data to adjust speed, avoiding overshoot), then ramps the TMP to 95% RPM to reach 1×10⁻¹¹ Torr (syncing with LAM 716-028721-268 to maintain ±0.5×10⁻¹¹ Torr stability).
Reduces roughing-to-UHV time by 18% (from 15 minutes to 12.3 minutes per lot) via optimized pump ramp rates, enabling 6 extra lots processed daily (180 additional wafers/month).
Detects a TMP bearing wear (via vibration monitoring) 2 weeks early, scheduling a planned replacement during a maintenance window—avoiding a 4-hour unplanned shutdown ($320,000 in saved production).
Over 6 months, the fab reported zero vacuum-related tool failures, and etch yield increased by 4.5%—equivalent to $6.0M in additional revenue.
Scenario 2: LAM 2300 Series High-Precision ALD for 3D NAND
A U.S. fab deploys LAM 810-802902-208 controllers in 32 LAM 2300 ALD systems for 3D NAND memory (200+ layer stacks). The controller:
Maintains 8×10⁻¹² Torr UHV during ALD by syncing TMP speed (90% RPM) with LAM 716-028721-268 pressure data—adjusting speed by ±2% to counteract pressure spikes from precursor injection.
Uses LAM 716-027740-001 data to control post-ALD venting: ramping the backing pump from 50% to 20% RPM as pressure rises from 1×10⁻⁴ Torr to 10 Torr, preventing turbulent airflow that causes “film stacking” defects.
This setup maintained 3D NAND film uniformity within ±0.9% (exceeding the fab’s ±1.2% target) across 25,000 wafers and reduced ALD-related defects by 38%, supporting the fab’s 2.0M 3D NAND chip monthly production goal.
Need a Custom Automation Solution?
Our team of experts can design and implement a tailored automation system to meet your specific requirements.

 Loading comments...
Loading comments...